「High-NA EUV」──半導体ニュースで急に聞くようになったこの言葉、こんなふうに感じていませんか?
- EUVは知ってるけど、「High-NA」って何が「高い」の?
- 「開口数0.55」と言われても、何が変わるのかピンとこない
- 1台500億円って本当?普通のEUVと何が違うの?
- IntelとTSMCで採用方針が違うらしいけど、どういう判断なの?
- 2nm世代の主役って言われるけど、自分のキャリアや投資にどう関係するの?
- High-NA EUVの定義と「NA0.55」の意味を初心者向けに
- 従来EUVとの性能差──解像度・スループット・精度
- アナモルフィックレンズという独自の光学設計の謎
- Intel 14A vs TSMC A14──採用判断が分かれた理由
- レジスト・マスク・コストという3つの課題
- ASML・Zeiss・Cymerの独占サプライチェーン
- 投資家・学生・技術者にとっての意味
High-NA EUVとは、レンズの「開口数(NA)」を0.33から0.55に引き上げたEUV露光装置です。これにより1回の露光で印刷できる線幅が13nm→8nmに縮小、2nm世代以降の微細化に必須の技術となります。ASMLが世界で唯一製造でき、1台あたり約4億ドル(約630億円)。Intelは14Aで業界初の量産導入を進める一方、TSMCはコスト効率を理由にA14世代では従来EUVを継続。レンズはZeiss、光源はCymer(ASML子会社)の独占体制で、サプライチェーンの寡占がさらに強化される構造です。微細化の限界を突破する「最後の切り札」と呼ばれる一方、レジスト・マスク・経済性という未解決課題も抱える──それがHigh-NA EUVの現在地です。
| 回 | タイトル | 区分 |
|---|---|---|
| 第1回 | リソグラフィとは?「設計図を焼き付ける」工程 | 入口 |
| 第2回 | リソグラフィ光源の歴史|i線→KrF→ArF→EUV | 時系列 |
| 第3回 | ArF液浸露光とは? | 技術 |
| 第4回 | EUVとは?13.5nmの極端紫外線 | 技術 |
| 第5回 | 📍 High-NA EUVとは?2nm世代の主役(この記事) | 次世代 |
| 第6回 | マルチパターニングとは? | 補完 |
| 第7回 | フォトマスク・レチクルとは? | 材料 |
| 第8回 | レジストとは?光で変質する薬品 | 材料 |
| 第9回 | ASMLが世界を握る理由|EUV独占の構造 | 業界 |
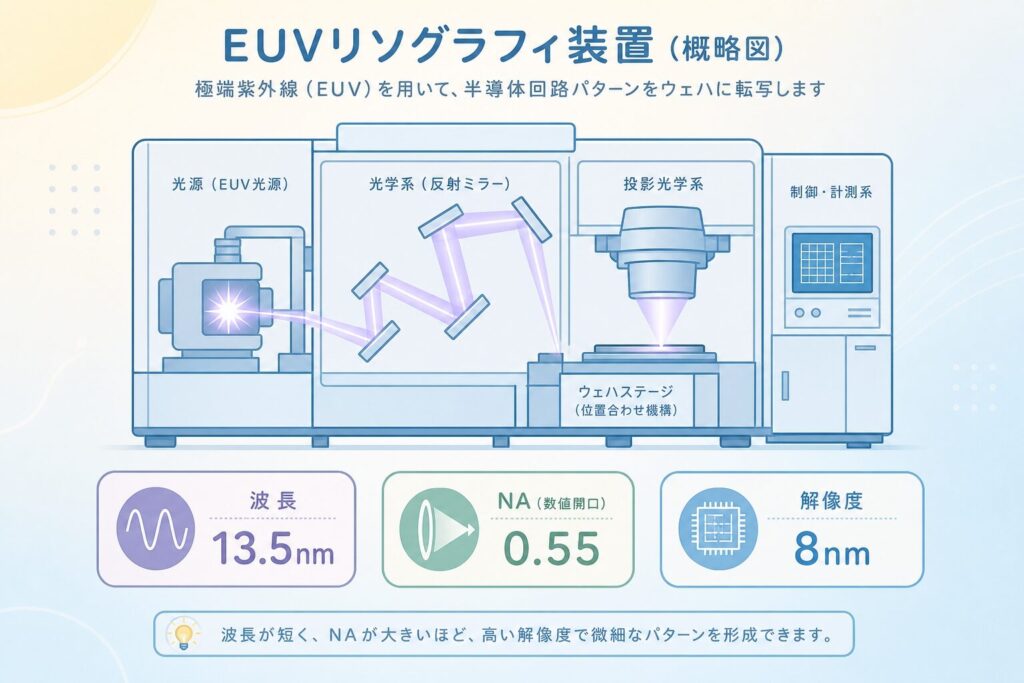
- High-NA EUVとは?──まず30秒で全体像をつかむ
- 従来EUVとの違い──「NA0.33 → 0.55」が意味すること
- アナモルフィックレンズ──High-NA EUV独自の「縦長の世界」
- ASMLのHigh-NA EUV装置──EXE:5000からEXE:5200Bへ
- Intel vs TSMC ── 採用判断が分かれた理由
- High-NA EUVが抱える3つの課題
- High-NA EUVの関連企業マップ
- 🇯🇵 日本メーカーが関わる重要領域
High-NA EUVとは?──まず30秒で全体像をつかむ
🔍 「High-NA」=「高い開口数」のEUV装置
High-NA EUV(ハイ・エヌエー・イーユーブイ)とは、従来のEUV露光装置のレンズの「開口数(NA:Numerical Aperture)」を0.33から0.55に引き上げた、次世代のEUV露光装置のことです。ASMLが世界で唯一製造しています。
名前の通り、波長は従来EUVと同じ13.5nm。光源(Cymer製)も従来EUVから流用されます。違うのは「光を集める仕組み」──レンズ系をZeissがゼロから再設計したことで、より細い線を1回の露光で印刷できるようになりました。
従来EUVが「標準レンズの一眼カメラ」だとすると、High-NA EUVは「大口径の望遠レンズに付け替えた一眼カメラ」です。光を集める力(NA)が上がるほど、より細かいディテールを撮影できる──これがNAという指標の本質です。同じ光源(13.5nm)でも、レンズが変われば見える世界が変わります。
レンズが光を集める能力を表す数値。NAが大きいほど、より斜めから入る光まで取り込めるため、解像度が上がる。半導体露光装置の解像度は「波長 ÷ NA」に比例するため、波長を変えずにNAを上げれば解像度が向上する。従来EUV:NA=0.33、High-NA EUV:NA=0.55。
📦 High-NA EUVの役割を1枚で見る
8nm線幅を印刷

従来EUVとの違い──「NA0.33 → 0.55」が意味すること
📐 NAが上がると何が変わるのか
半導体露光装置の解像度は、レイリーの式で「解像度 = k1 × 波長 ÷ NA」と表されます。波長(13.5nm)を変えずに、NAを0.33から0.55に上げると──解像度は理論上約1.7倍向上します(参考:High NA EUV解説)。
ASML公式によれば、TWINSCAN EXE:5000は1回の露光で8nmの線幅を印刷可能です(出典:ASML公式)。これは従来EUVなら「2回の露光(ダブルパターニング)」が必要だった微細パターンを、High-NA EUVなら「1回」で済ませられることを意味します。
📊 従来EUV vs High-NA EUV ── 6項目比較
| 比較項目 | 従来EUV (TWINSCAN NXE:3800E) |
High-NA EUV (TWINSCAN EXE:5200B) |
|---|---|---|
| 開口数(NA) | 0.33 | 0.55 |
| 解像度(線幅) | 約13nm | 約8nm |
| スループット | 220wph〜 | 175wph(50mJ/cm²時) |
| オーバーレイ精度 | 約1.1nm | 0.7nm |
| レンズ系 | 対称型 | アナモルフィック (縦8倍/横4倍) |
| 価格(1台) | 約2億ドル(約300億円) | 約4億ドル(約630億円) |
出典:解像度・NAは ASML公式、スループット・オーバーレイは XenoSpectrum、価格は BiggoFinance を参考に構成
オーバーレイ精度0.7nmとは、「前の露光で焼いたパターンの上に、次の露光で焼くパターンを0.7nm以内のズレで重ねる」という意味です。これは原子の直径の数個分に相当する精度。半導体製造が「精密機械の頂点」と呼ばれる所以です。

アナモルフィックレンズ──High-NA EUV独自の「縦長の世界」
🪞 NAを上げただけでは解決できない「反射率の壁」
EUVを理解するうえで重要なのは、EUV光は通常のレンズを透過しないということです。EUV光は物質に吸収されやすいため、レンズの代わりに多層膜ミラーを使って光を曲げます。
NAを単純に上げると、ミラーへの光の入射角が大きくなりすぎ、反射率が大幅に低下してしまいます。これでは光が弱くなりすぎて使い物になりません。Zeissがこの問題を解決するために編み出したのが、アナモルフィック光学系です(参考:tm-co)。
縦と横で異なる倍率を持つ光学設計。映画撮影で「シネマスコープ」を撮るために発明された技術。High-NA EUVでは、縦方向(Y軸)は8倍縮小、横方向(X軸)は4倍縮小という非対称設計を採用。これにより、ミラーへの入射角を抑えつつ、必要なNAを実現する。
🎬 「映画のシネマスコープ」と同じ発想
アナモルフィックレンズは、「画像を縦方向にだけ強く圧縮する魔法のレンズ」のようなものです。映画でワイドな画面を作るとき、フィルムは正方形に近い形なので、横長の風景をフィルムに収めるには横方向だけ圧縮して撮影します。映写するときに横方向だけ伸ばせば、元のワイド画面に戻る。High-NA EUVでも同じ発想で、縦方向だけ強く縮小することで、必要な解像度と反射率を両立しています。
⚠️ 「ハーフフィールド」という代償
アナモルフィック設計の代償として、1回の露光で焼ける範囲(フィールド)が従来EUVの半分になるという制約があります。これが業界で「ハーフフィールド」と呼ばれる現象です。
・1回の露光面積:26 × 33 mm
・大きな半導体チップも1ショットで露光可能
・縦・横とも4倍縮小(対称型)
・1回の露光面積:26 × 16.5 mm(半分)
・大きなチップは2回露光して「縫い合わせる」
・縦8倍/横4倍(アナモルフィック)
大きなGPUダイ(NVIDIA H100の814mm²など)を作る場合、High-NA EUVでは2回の露光でパターンを「縫い合わせる」必要があります。この縫い目が完全には消えないため、AIアクセラレータのような大型ダイの製造には追加の工夫が求められます。

ASMLのHigh-NA EUV装置──EXE:5000からEXE:5200Bへ
📅 進化のタイムライン
ASMLは現在2世代のHigh-NA EUV装置を提供しています。第1世代の「EXE:5000」は研究開発(R&D)向け、第2世代の「EXE:5200B」は量産向けです。
業界初のHigh-NA EUV装置。Intelのオレゴン州R&Dファブに最初に納入。研究開発・プロセス開発向けで、解像度8nmを実証。
第2世代の量産向けHigh-NA EUV。スループット175wph、オーバーレイ0.7nmを達成。Intelが業界初の商用導入を発表。
ベルギーの研究機関imecがEXE:5200を受領。「産業規模への拡張」を目指す検証フェーズへ(出典:EE Times)。
Intelは14A(1.4nm相当)プロセスでHigh-NA EUVを本格採用予定。リスク生産は2027年、量産は2028年を計画(出典:セミコンポータル)。
📊 EXE:5000 vs EXE:5200B の主な違い
| 項目 | EXE:5000(第1世代) | EXE:5200B(第2世代) |
|---|---|---|
| 主な用途 | 研究開発(R&D) | 量産(HVM) |
| スループット | 約160wph | 175wph(50mJ/cm²) |
| オーバーレイ精度 | 約1.0nm | 0.7nm |
| 熱・振動安定性 | 標準 | 大幅強化 |
| 代表ユーザー | Intel(オレゴン)、Samsung、SK Hynix | Intel(14A量産)、imec |
出典:ASML公式(EXE:5200B)、XenoSpectrum

Intel vs TSMC ── 採用判断が分かれた理由
⚔️ 「先行投資のIntel」vs「コスト優先のTSMC」
High-NA EUVをめぐって、世界の2大ファウンドリは正反対の判断を下しました。これは技術ロードマップの違いというより、事業戦略の違いを反映しています。
Intel:業界初の量産導入
- 14A(1.4nm相当)プロセスで本格採用
- 2027年リスク生産、2028年量産
- 2023年にEXE:5000を業界最初に納入
- 2025年にEXE:5200Bを商用導入
- 戦略:技術リーダーシップを取り戻す
「Intel Foundry」事業の差別化
TSMC:A14世代では「見送り」
- A14(1.4nm相当・2028年量産予定)では従来EUV継続
- マルチパターニングで対応
- High-NA EUV採用は次世代以降に先送り
- 戦略:成熟技術で歩留まりとコストを優先
顧客のリスクを最小化
TSMCの判断について、同社は「自社R&Dチームは、High-NAを使用しなくても従来EUVのマルチパターニングで十分な性能・歩留まりを達成できる」と説明しています(出典:マイナビニュース)。1台4億ドルのHigh-NA EUVを大量導入するより、既存EUVを工夫して使う方が経済合理性が高いという判断です。
High-NA EUVを最初に量産導入することで、Intelは2nm以細の世代でTSMCに技術的優位を取り戻す狙いがあります。一方TSMCは「枯れた技術で安定供給」という強みを維持。両社の判断のどちらが正解かは、2027〜2028年の量産結果で明らかになります。
TSMCがA14でHigh-NAをスキップするのは事実ですが、「永遠に使わない」わけではありません。A14P(A14の改良版)以降、必要に応じて段階的に導入する可能性があります。「いま使うかどうか」の判断にすぎず、将来的にHigh-NA EUVが業界標準になる流れは変わりません。

High-NA EUVが抱える3つの課題
High-NA EUVは万能ではありません。実用化に向けて3つの構造的課題を抱えています。これらを理解することが、技術の現在地を正しくつかむうえで重要です。
レジストの感度・解像度の限界
High-NA EUVは光量が少ないため、感度の高い専用レジストが必要です。同時に8nm線幅を解像できる解像度も求められます。「感度」と「解像度」は一般にトレードオフ関係にあるため、両立する材料の開発が大きな課題です。JSR・東京応化工業・信越化学などの日本メーカーが開発を主導しています。
マスクの精度要求
アナモルフィックレンズに対応するため、マスク(レチクル)も非対称な縦長パターンで設計する必要があります。マスク自体の欠陥許容度も極めて低く、欠陥1つで歩留まりが大きく落ちます。マスク検査・修復装置の重要性が高まり、KLA・レーザーテック(6920)の役割が拡大しています。
装置価格と経済性
1台約4億ドル(約630億円)。従来EUVの2倍の価格です。さらに保守・電力・クリーンルーム面積などの運用コストも増大。歩留まりが安定するまでは、High-NA EUVを採用するチップは製造コストが大幅に上がるリスクがあります。これがTSMCがA14でスキップを選んだ最大の理由です。
High-NA EUVは装置・レジスト・マスク・プロセス・設計の5つすべてが揃って初めて意味を持ちます。Intelが業界初の量産導入に挑むということは、これら5要素すべてを業界に先駆けて成熟させる責任を負うことを意味します。

High-NA EUVの関連企業マップ
High-NA EUVのサプライチェーンは、極めて寡占的です。装置・コア部品・ユーザー(採用企業)の3面で整理します。
装置メーカー
- ASML(ASML.AS)
世界唯一のHigh-NA EUV装置メーカー
コア部品メーカー
- Carl Zeiss SMT(非上場)
アナモルフィックレンズ・多層膜ミラー - Cymer(ASML子会社)
EUV光源(13.5nm) - TRUMPF(非上場)
光源用高出力CO₂レーザー
採用企業(ユーザー)
- Intel(INTC)
14Aで業界初の量産採用 - Samsung Foundry(005930.KS)
R&D採用、2nm世代以降で検討 - SK Hynix(000660.KS)
HBMやDRAM向けに検討 - imec(ベルギー研究機関)
業界共通の検証拠点
🇯🇵 日本メーカーが関わる重要領域
装置メーカーとしての日本企業はHigh-NA EUVには参入していませんが、レジスト・マスク・検査の周辺領域で重要なポジションを占めています。
東京応化工業(4186)、
信越化学(4063)、
富士フイルム(4901)
AGC(5201)、
TOPPAN(7911)、
大日本印刷(7912)
(米KLAと並ぶ世界2強)

あなたにとっての意味──投資家・学生・技術者の視点
High-NA EUVは「ASML一強」をさらに強化する技術です。1台4億ドルの装置を世界で唯一製造できる──この事実だけでもASMLの構造的な強さがわかります。さらに視野を広げると、レーザーテック(6920)のマスク検査独占、HOYA(7741)のマスクブランクス、JSR・東京応化工業・信越化学のEUVレジストなど、日本企業も寡占ポジションを保っています。「ASML株は買えないけど周辺で投資したい」という方にとって、これらは構造的な追い風銘柄です。
High-NA EUVは光学・物理・材料・精密機械・ソフトウェア・統計すべてが交わる技術です。アナモルフィックレンズの設計(Zeiss)、多層膜ミラーの材料(モリブデン/シリコン)、レジストの分子設計(化学)、装置の振動制御(精密機械)──理工系ほぼすべての専攻が活きる分野です。「半導体=情報系」という思い込みを壊す、最も強い具体例の1つです。レーザーテックや信越化学のような日本企業を志望する学生にとって、High-NA EUVの理解は面接で大きな差別化になります。
High-NA EUVの実用化は、装置1台で完結するものではありません。クリーンルーム設計、振動制御、温度安定化、電力供給、CDU(冷却液分配ユニット)、マスク管理、レジストプロセス──これらすべてが新たな精度要求と向き合います。1台500億円超の装置を支える周辺インフラを設計・運用できる技術者は、業界で最も不足している人材です。
よくある誤解を整理する
| ❌ よくある誤解 | ✅ 実際はこう |
|---|---|
| 「High-NA EUVは全く新しい光源を使う」 | 光源は従来EUVと同じ13.5nmの極端紫外線。変わったのはレンズ系(NA0.33→0.55)のみ。Cymer製の光源も流用されている。 |
| 「TSMCはHigh-NAに乗り遅れている」 | TSMCは戦略的にA14での採用を見送っただけ。マルチパターニングで対応できるという技術判断であり、必要になれば即座に導入できる体制を持つ。 |
| 「High-NA EUVがあれば微細化は無限に進む」 | High-NA EUVでも理論的限界はある。次は「Hyper-NA EUV」(NA0.7超)の構想があるが、ミラー設計・コストの壁が立ちはだかる。微細化は段階的にしか進まない。 |
| 「日本メーカーはHigh-NA EUVに関係ない」 | レジスト・マスクブランクス・マスク検査で日本メーカーが世界シェア上位を占める。装置本体には関わらないが、High-NA EUV普及の追い風を受ける構造。 |
| 「アナモルフィックレンズはコスト削減のため」 | 逆。アナモルフィック設計は反射率を確保するための物理的必然であり、その代償としてハーフフィールドという制約を生んでいる。 |

まとめ:High-NA EUVを5点で整理する
① High-NA EUVとは:NAを0.33から0.55に引き上げた次世代EUV装置。波長は13.5nmで同じ、レンズだけが進化した。
② 性能向上:解像度8nm(従来13nm)、オーバーレイ精度0.7nm、スループット175wph。1回の露光で従来のダブルパターニング相当を実現。
③ アナモルフィックレンズ:反射率確保のため縦8倍/横4倍の非対称設計。代償として露光フィールドが半分に。
④ 採用判断:Intelは14Aで業界初の量産採用、TSMCはA14世代では見送り。事業戦略の違いが採用時期を分けた。
⑤ サプライチェーン:装置はASML独占、レンズはZeiss、光源はCymer(ASML子会社)。日本はレジスト・マスク・検査で重要ポジション。
結局こういうことです。High-NA EUVは「光源を変える」のではなく「光の集め方を変える」次世代装置です。1台500億円超という途方もないコストの裏には、ナノメートルの世界で原子数個分の精度を保つための、Zeiss・ASML・Cymerが10年以上かけて積み上げた技術の塊があります。微細化の限界を突破する「最後の切り札」と呼ばれる一方、レジスト・マスク・経済性という未解決課題も多い──それがHigh-NA EUVの現在地です。
❓ よくある質問(FAQ)

次に読むべき記事
High-NA EUVを理解したら、次は「なぜ従来EUVで限界が来るのか/どうしのいでいるのか」を補完技術側から見ていきましょう。
📚 リソグラフィ完全シリーズ(全9記事)── 詳細版
リソグラフィシリーズは全9記事の体系的な学習ロードマップです。順番に読むと「光をどう半導体に焼き付けるか」の全体像が掴めます。
| 第1回 |
リソグラフィとは?「設計図を焼き付ける」工程
シリーズの入口。半導体製造で最も重要な「露光」の全体像
|
| 第2回 |
リソグラフィ光源の歴史|i線→KrF→ArF→EUV
なぜ波長を短くしてきたのか。50年の進化を時系列で
|
| 第3回 |
ArF液浸露光とは?
水を使って解像度を上げる発想の転換。EUV以前の主役
|
| 第4回 |
EUVとは?13.5nmの極端紫外線
7nm以細の世代に必須の技術。仕組み・装置・現状を解説
|
| 第5回 |
📍 High-NA EUVとは?2nm世代の主役(この記事)
NA0.55の次世代装置。Intel 14Aで業界初の量産導入へ
|
| 第6回 |
マルチパターニングとは?
High-NA EUVを使わずに微細化する「もう一つの道」
|
| 第7回 |
フォトマスク・レチクルとは?
露光の「型」となる重要部品。日本企業が強い領域
|
| 第8回 |
レジストとは?光で変質する薬品
JSR・東京応化・信越化学・富士フイルムの世界寡占構造
|
| 第9回 |
ASMLが世界を握る理由|EUV独占の構造
シリーズの締め。なぜASML一強が崩れないのかを業界構造で解説
|
📩 記事の更新情報を受け取りたい方へ
新しい記事が公開されたら、Xアカウント @shirasusolo でお知らせします。半導体プロセスの構造を一緒に学んでいきましょう。



コメント