「熱酸化」──シンプルそうな名前なのに、半導体の世界では今でも欠かせない超重要工程です。でも、こんなふうに感じていませんか?
- 「熱酸化」と「CVD」、どっちもSiO₂膜を作るのに何が違うの?
- ドライ酸化とウェット酸化って、どう使い分けてるの?
- 「ゲート酸化膜」が大事と聞くけど、なぜそこまで重要?
- 古典的な工程に見えるのに、なぜ最新の半導体でも残っているの?
- 熱酸化の仕組み──シリコンを「焼く」とは具体的に何が起きているか
- ドライ酸化とウェット酸化の違いと使い分け
- ゲート酸化膜が「半導体の心臓」と呼ばれる理由
- 熱酸化装置で世界をリードする日本企業(KOKUSAI ELECTRIC・東京エレクトロン)の強み
- 投資家・学生・技術者にとっての意味
熱酸化(Thermal Oxidation)とは、シリコンウェーハを高温(700〜1,200℃)の酸素や水蒸気にさらすことで、表面のシリコン原子を酸化させて二酸化ケイ素(SiO₂)の絶縁膜を作る工程です。CVDなどと違って、膜を「上から積む」のではなく「シリコン自体を変質させる」のが最大の特徴。これにより、世界で最も品質の高い絶縁膜が作れます。最先端ロジックでは「High-k膜」に置き換えられた部分もありますが、パワー半導体・3D NAND・CMOSの周辺領域では今も主役です。装置市場では、日本のKOKUSAI ELECTRIC(6525)と東京エレクトロン(8035)が縦型炉(バッチ式装置)で世界の主導権を握っています。
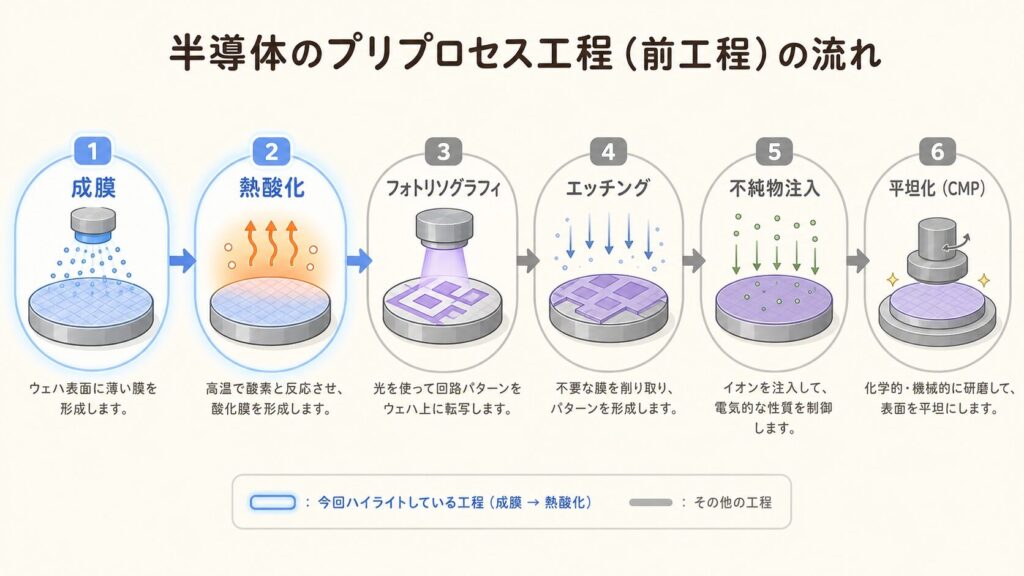
熱酸化とは?──シリコンを「焼く」とは何が起きているのか
🔥 一言でいうと「シリコンの表面を酸素で焦がして膜にする」
熱酸化とは、シリコンウェーハを700〜1,200℃の高温で酸素または水蒸気にさらし、表面のシリコン原子を酸化させて二酸化ケイ素(SiO₂)の薄膜を作る工程です。
ここで一番大事なポイントは、「膜を上から積み重ねている」のではないということ。CVDやPVDなど他の成膜方法は外からガスや金属粒子を持ってきてウェーハ表面に「乗せる」のですが、熱酸化はシリコンウェーハ自体の表面が、酸素と結びついて変身するのです。
ステーキを焼くのを思い浮かべてください。表面が焦げて茶色くなりますよね。あれは「焦げ」を上から塗ったのではなく、肉の表面が高温で変質した結果です。熱酸化も同じ。シリコンウェーハ表面のシリコン原子が、酸素と反応して「SiO₂」というまったく別の物質になります。「焼き目」が膜になる──これが熱酸化の正体です。
シリコン原子1つに酸素原子2つが結合した物質。実はガラスや石英の主成分でもあり、地球の地殻で最も豊富な化合物の1つ。半導体では絶縁膜として極めて重要な役割を果たす。電気を通しにくく、化学的に安定で、シリコン基板との相性が抜群。
🧪 化学反応で見るとシンプル
熱酸化で起きている化学反応は、実はたった2つです。
2つの方法はどちらも最終的にSiO₂を作りますが、速度・品質・厚さの限界が違うため使い分けます。詳しくは次の章で見ていきましょう。

熱酸化工程の役割を1枚で理解する

ドライ酸化 vs ウェット酸化──「速さ」と「品質」のトレードオフ
⚖️ 2つの方法は「真逆の特徴」を持つ
熱酸化には2種類あります。酸素ガスを使う「ドライ酸化」と、水蒸気を使う「ウェット酸化」です。同じSiO₂を作るのに、なぜ2種類あるのか? それは2つが正反対の長所と短所を持っているからです。
パンの焼き方に似ています。ドライ酸化は「弱火でじっくり焼く」──時間はかかるけど、表面がきめ細かい高品質な仕上がりに。ウェット酸化は「強火で蒸し焼き」──短時間でふっくら厚く焼けるけど、きめ細かさはやや劣る。料理と同じで、用途によって焼き方を変えるのです。
ドライ酸化
反応:Si + O₂ → SiO₂
速度:遅い(数時間)
品質:★★★★★ 非常に高い
厚さ:薄い膜が得意(〜100nm)
主な用途:ゲート酸化膜(最重要)
ウェット酸化
反応:Si + 2H₂O → SiO₂ + 2H₂
速度:速い(ドライの数倍〜10倍)
品質:★★★ 普通
厚さ:厚い膜が得意(〜数百nm)
主な用途:素子分離(LOCOS)等
📊 一覧比較表で違いを整理
| 比較項目 | 🌬️ ドライ酸化 | 💧 ウェット酸化 |
|---|---|---|
| 使うガス | 酸素 (O₂) | 水蒸気 (H₂O) |
| 成長速度 | 遅い | 速い(数倍〜10倍) |
| 膜の緻密さ | 非常に高い | やや低い |
| 電気的特性 | 優秀 | 普通 |
| 向く膜厚 | 薄膜(〜100nm) | 厚膜(〜数百nm) |
| 代表用途 | ゲート酸化膜 | 素子分離(LOCOS)、フィールド酸化膜 |
出典:Semi journal、OTIS Group技術解説を参照
最も大事な「ゲート酸化膜」には必ずドライ酸化を使います。トランジスタの心臓部なので、品質を絶対に妥協できないからです。一方、トランジスタとトランジスタを電気的に分離する「フィールド酸化膜」は厚くしたいので、ウェット酸化が選ばれます。「品質ならドライ・厚さならウェット」と覚えてください。

ゲート酸化膜──なぜ「半導体の心臓」と呼ばれるのか
💎 トランジスタが「動くか動かないか」を決める1枚の膜
熱酸化で作られる膜の中で、特に重要なのが「ゲート酸化膜(ゲート絶縁膜)」です。これは半導体の基本素子であるMOSトランジスタの中心にある、たった数nmの薄膜です。
トランジスタを「水門」だと思ってください。電流(水)を流すか止めるかを決めるのが「ゲート」です。そしてゲートの下にある絶縁膜が、水門の仕切り板。仕切り板が薄すぎれば水が漏れて止まらない、厚すぎれば操作が効かない。絶妙な厚さが性能を決めるのです。
📐 ゲート酸化膜の進化──年々薄くなり続けてきた
ゲート酸化膜の厚さは、半導体の世代が進むにつれてどんどん薄くなってきました。これが半導体性能を上げてきた歴史でもあります。
熱酸化で十分対応可能。ドライ酸化で高品質なSiO₂膜を作ることが性能向上の主役だった時代。
SiO₂が薄くなりすぎてリーク電流(電気の漏れ)が問題に。65nm世代以降は熱酸化+窒化で「SiON」膜が主流になる。
45nm世代以降、最先端ロジックではSiO₂より誘電率の高いHfO₂(酸化ハフニウム)などのHigh-k膜に置き換わる。ただし熱酸化は今もパワー半導体・3D NAND・周辺領域で主役。
SiO₂より誘電率(k値)が高い絶縁膜の総称。HfO₂(ハフニア)が代表格。SiO₂より物理的に厚くしてもトランジスタ性能が出るため、リーク電流問題を解決した。最先端ロジックではALD装置で形成される。
「最先端ロジックでHigh-k膜に置き換わったから、熱酸化はもう古い技術」と思われがちですが、これは半分間違いです。パワー半導体(SiC・自動車用途)、3D NANDメモリ、CMOSの周辺領域では今も熱酸化が主役。むしろEV・AIサーバー需要の拡大でパワー半導体が伸びており、熱酸化装置の需要は今後も底堅いと見られています。
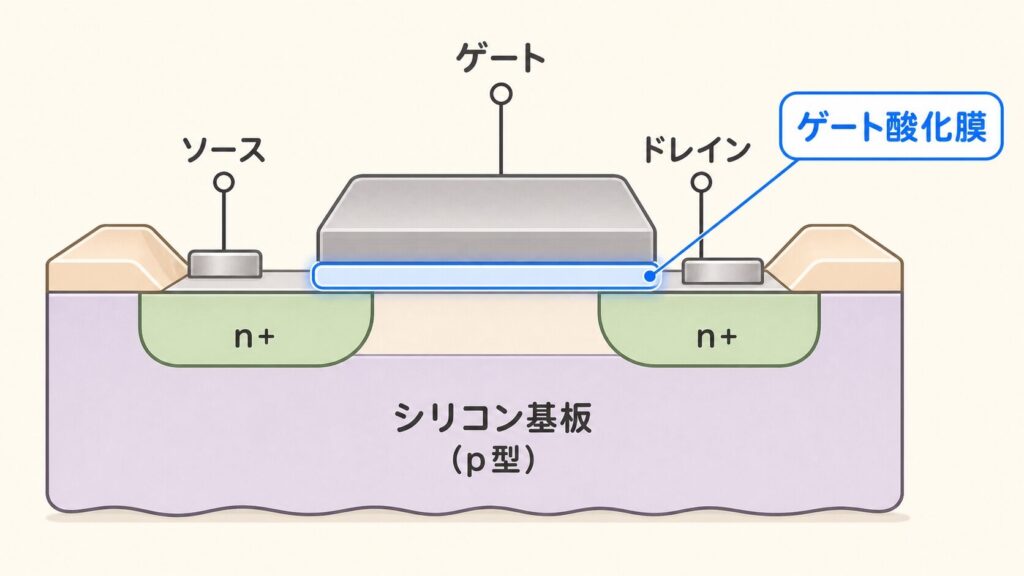
熱酸化はどの世代で主役か?
最先端ロジックでは補助的役割になったが、SiCパワー半導体や3D NANDでは引き続き主役。
📐 熱酸化が扱う精度
最も薄いゲート酸化膜(〜2nm)はDNA二重らせんと同じレベル。

熱酸化装置の関連企業マップ──「日本企業が世界をリードする領域」
🏭 縦型炉(バッチ式装置)は日本企業の独壇場
熱酸化を行う装置は、主に「縦型炉(バッチ式装置)」と呼ばれるもの。一度に数十〜100枚以上のウェーハをまとめて処理する高生産性が特徴です。この縦型炉の世界では、日本企業が圧倒的な存在感を持っています。
装置メーカー
- KOKUSAI ELECTRIC(6525)
縦型炉のリーディングカンパニー。バッチ成膜・トリートメント装置で世界高シェア - 東京エレクトロン(8035)
成膜装置 世界シェア約39%。熱酸化を含む拡散炉も主力製品 - Applied Materials(AMAT)
枚葉式酸化装置で一定シェア
材料・ガス供給
- 大陽日酸(日本酸素HD)(4091)
高純度酸素・特殊ガスのトップ供給 - エア・ウォーター(4088)
産業ガス供給 - レゾナック(4004)
関連材料
使う側(ユーザー)
- TSMC(2330.TW)
世界最大ファウンドリ - Samsung(005930.KS)
3D NAND・ロジック - キオクシア(285A)
3D NAND - ロームなどパワー半導体メーカー
SiC等で熱酸化が主役
🇯🇵 KOKUSAI ELECTRICの強さの源泉
KOKUSAI ELECTRICの源流は、1963年に国産初のホットウォール型横型拡散炉「DD-1」を販売した国際電気にさかのぼります。60年以上にわたり熱処理装置(酸化・拡散・CVD)を進化させてきた、世界でも希少な存在です。
最新の代表機種「TSURUGI-C²®(剱)」は次世代デバイス向けの高難易度成膜と高生産性を両立するサーマルプロセス装置。3D NAND高層化やGAA時代に対応した縦型炉として、世界の最先端メーカーに採用されています。
国産化スタート
100枚+
処理できるウェーハ枚数
1,200℃
処理温度
出典:日本半導体歴史館、KOKUSAI ELECTRIC公式、同社IR資料を参照

あなたにとっての意味──投資家・学生・技術者の視点
熱酸化装置は「最先端ロジックではない」がゆえに、別の成長ドライバーを持っています。EV・自動車向けのSiCパワー半導体、3D NANDの高層化、車載・産業用のCMOS──いずれも熱酸化装置の需要を底堅く支える領域です。最先端ロジックの「ALD成長」とは別の、パワー半導体・メモリ領域の長期成長として、KOKUSAI ELECTRIC(6525)と東京エレクトロン(8035)の動きが注目されます。
熱酸化は「化学・材料・物理」が交差する古典的かつ奥の深い分野です。Deal-Groveモデルのような酸化メカニズムの理論研究は今も続いており、SiCやGaNなど新材料の酸化メカニズムは未解明の部分も多い。研究テーマとしても、装置メーカー就職としても面白い領域です。
熱酸化は装置・温度プロファイル・ガスフロー・ウェーハ配置のすべてが膜質に影響する繊細な工程です。バッチ式と枚葉式の使い分け、酸化レートの面内均一性、不純物管理──現場ノウハウが直接歩留まりに反映される領域です。「古典的な工程」と侮らず、若手のうちに体系的に学ぶ価値があります。
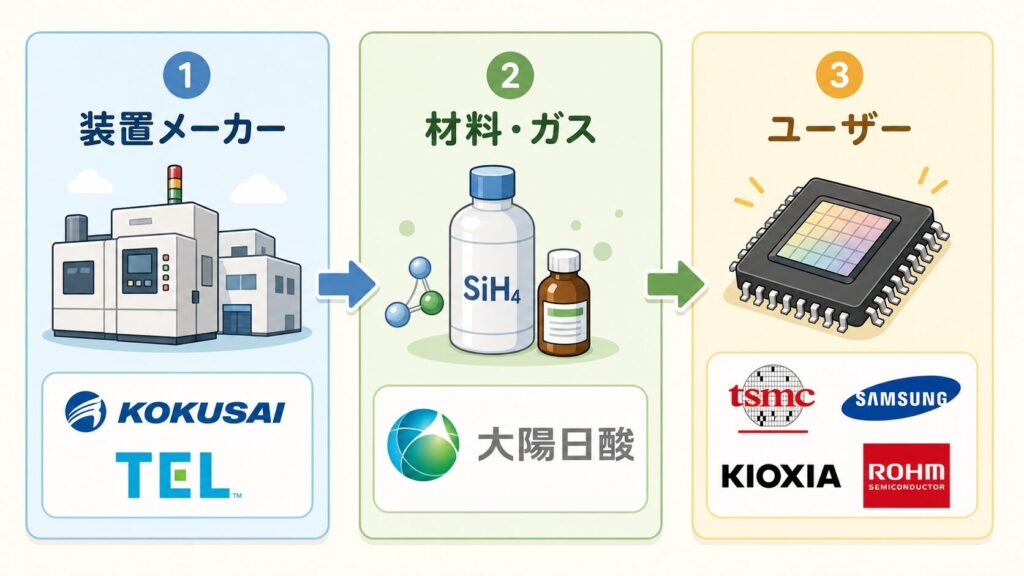
よくある誤解を整理する
| ❌ よくある誤解 | ✅ 実際はこう |
|---|---|
| 「熱酸化はCVDと同じようなもの」 | 熱酸化はシリコン自体を変質させるのに対し、CVDは外から膜を積み重ねる。原理がまったく違い、できる膜の品質も別物。 |
| 「熱酸化はもう古い技術」 | 最先端ロジックでは補助的だが、SiCパワー半導体・3D NAND・周辺回路では今も主役。EV化・AIサーバーで需要は底堅い。 |
| 「ドライ酸化のほうが優れている」 | 品質は高いが速度が遅い。厚膜を作るならウェット酸化のほうが効率的。「品質ならドライ・厚さならウェット」の使い分けが鉄則。 |
| 「熱酸化装置は単純な炉」 | 温度均一性・ガスフロー・パーティクル制御・面内均一性──すべてに数十年のノウハウの蓄積が必要。だから日本企業(KOKUSAI ELECTRIC・東京エレクトロン)が世界をリード。 |
| 「ゲート酸化膜は熱酸化で作られている」 | 最先端ロジック(45nm以降)ではHfO₂などのHigh-k膜にALDで形成。ただしSiC等のパワー半導体や非最先端領域では今も熱酸化。 |

まとめ:熱酸化の全体像
① 熱酸化とは:シリコンウェーハを高温(700〜1,200℃)の酸素・水蒸気にさらして表面を酸化させ、SiO₂膜を作る成膜法。
② 他の成膜法との違い:「上から積む」のではなく「シリコン自体を変質させる」のが特徴。だから極めて高品質な絶縁膜が作れる。
③ 2つの方式:ドライ酸化(O₂使用、品質重視・遅い)とウェット酸化(H₂O使用、速度重視・厚膜向き)。「品質ならドライ・厚さならウェット」。
④ ゲート酸化膜:トランジスタの心臓部。最先端ロジックではHigh-k膜に置き換わったが、SiCパワー半導体・3D NAND・周辺領域では今も主役。
⑤ 装置メーカー:縦型炉(バッチ式装置)はKOKUSAI ELECTRIC(6525)と東京エレクトロン(8035)の日本企業2社が世界をリード。
⑥ AI時代との接続:EV・パワー半導体・3D NAND需要で熱酸化装置の需要は底堅く、最先端ロジックとは別の成長ドライバーを持つ。
熱酸化は半導体製造の中で最も古典的な工程の1つですが、その重要性は今でも変わりません。「シリコンを焼いて変質させる」というシンプルな原理から、世界最高品質の絶縁膜が生まれる──この基本を押さえれば、CVDやALDといった他の成膜方法との違いも自然と見えてきます。
❓ よくある質問(FAQ)

📚 次に読むべき記事
熱酸化を理解したら、次は「上から膜を積む」成膜方法のCVDに進みましょう。熱酸化と並ぶ前工程の主役です。
🎓 成膜シリーズ全6記事
成膜の全体像と4つの方法を整理する入口記事
最も古典的な成膜法。SiO₂ゲート酸化膜を作る基本中の基本。
成膜の主力。LPCVDとPECVDの違いと使い分けを図解。
金属を物理的に弾き飛ばして膜にする方法。配線層の主役。
究極の精密成膜。AI半導体時代の成長領域。
業界構造の総括。投資家視点で4社寡占を解剖する。
📩 記事の更新情報を受け取りたい方へ
新しい記事が公開されたら、Xアカウント @shirasusolo でお知らせします。半導体プロセスの構造を一緒に学んでいきましょう。




コメント