「ArF液浸」──半導体製造のニュースで頻出する言葉ですが、こんなふうに感じていませんか?
- 「水に浸す」って聞いたけど、本当に水で半導体を作っているの?
- 同じArF(193nm)なのに、なぜ液浸だと「134nm相当」になるの?
- EUVが登場したのに、なぜ今もArF液浸が現役なの?
- 2025年の今、ニコンが「ASML互換ArF液浸装置」を出すと聞いて、その意味がよくわからない
- 「水を挟む」だけで波長が短くなる物理原理(屈折率の話)
- 装置の断面イメージ──どこに水が入るのか
- EUV時代でもArF液浸が主役を続ける理由
- マルチパターニングと組み合わせて5nmまで作れる仕組み
- ニコンとASMLの開発競争史と現在の構図
シリーズ第2回(光源の歴史)で「業界はF2レーザを諦めて、ArFに水を挟む奇策で乗り切った」と紹介しました。今回はその「奇策」の中身を、図解と比喩で一気に解説します。
| 回 | タイトル | 区分 |
|---|---|---|
| 第1回 | リソグラフィとは?「設計図を焼き付ける」工程 | 入口 |
| 第2回 | リソグラフィ光源の歴史|i線→KrF→ArF→EUV | 時系列 |
| 第3回 | 📍 ArF液浸露光とは?(この記事) | 技術 |
| 第4回 | EUVとは?13.5nmの極端紫外線 | 技術 |
| 第5回 | High-NA EUVとは?2nm世代の主役 | 次世代 |
| 第6回 | マルチパターニングとは? | 補完 |
| 第7回 | フォトマスク・レチクルとは? | 材料 |
| 第8回 | レジストとは?光で変質する薬品 | 材料 |
| 第9回 | ASMLが世界を握る理由|EUV独占の構造 | 業界 |

ArF液浸露光とは?──30秒で全体像
ArF液浸露光とは、波長193nmのArFエキシマレーザを使い、レンズと半導体ウェハの間を「水(屈折率1.44)」で満たして露光する技術です。空気中なら193nmの光が、水を通すことで実効的に約134nm相当の波長として振る舞い、より細い線が描けるようになります。2007年に量産化され、45nm世代から7nm世代まで10年以上にわたり業界を支えた主役技術。EUV登場後も「マルチパターニング併用で5nm世代まで対応可能」「EUVより装置コストが安い」「成熟ノードでも需要が大きい」という理由で、現在も新規装置が販売されています。
📦 この技術の役割
一見「水を入れるだけ」のシンプルなアイデアに見えますが、実際はナノメートル精度の超精密装置に水を導入することへの困難が山積みでした。気泡・温度変化・水質汚染・水との屈折率変化など、解決すべき課題は10年以上かけて潰してきたものです。
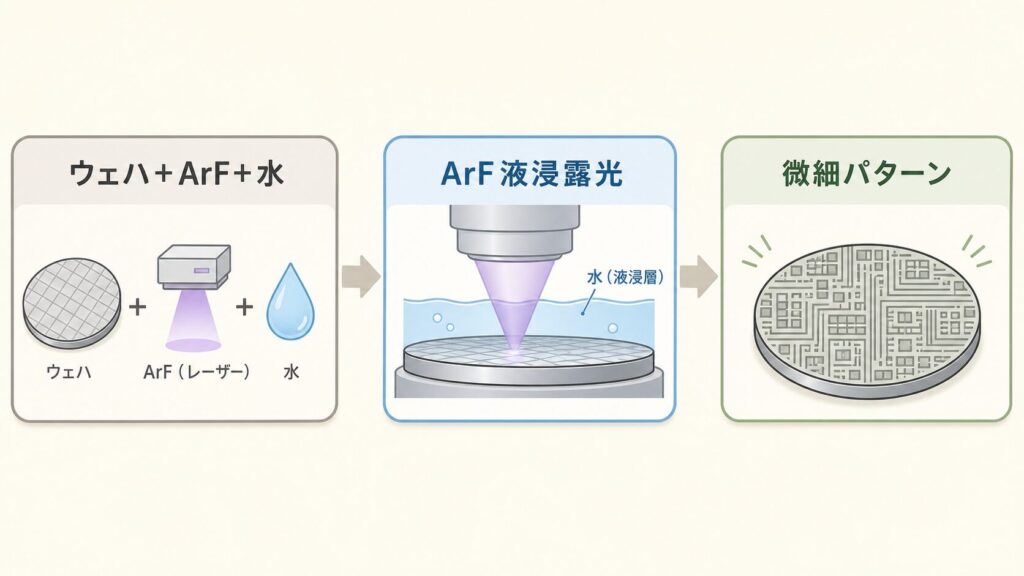
なぜ水を挟むと「波長が短くなる」のか
ここがArF液浸露光の心臓部です。物理の話ですが、たとえ話で押さえれば一発で腹落ちします。
プールサイドに棒を斜めに差し込むと、水面から下で「曲がって」見えますよね。あれは光が水中で速度を落とす(屈折率1.44倍ゆっくり進む)ためです。光の波長は「速度 ÷ 周波数」で決まるので、光が遅くなる=波長が短くなるということ。空気中193nm → 水中134nm(193 ÷ 1.44)。これが「水を挟むだけで波長が短くなる」物理的な仕組みです。
📐 装置の断面イメージ
水で満たされる隙間はわずか1mm程度。ウェハが動くたびに水も追従する精密制御が必要。
解像度がどれだけ上がるか
リソグラフィの解像度は R = k₁ × λ ÷ NA という式で決まります。λ(波長)が小さいほど、NA(開口数)が大きいほど、細い線が引けるという意味です。液浸では水の屈折率1.44がNAにも効くため、同じレンズでもNAが空気中の最大1.0から1.35〜1.4へ大幅に拡大。波長短縮(193→134nm)と合わせて、解像度が大きく改善します。
レンズが光を集める能力を示す数値。「どれだけ広い角度から光を集められるか」を表す。NAが大きいほど解像度が上がるが、空気中では1.0が物理的上限。液浸により1.35〜1.4まで拡大可能。
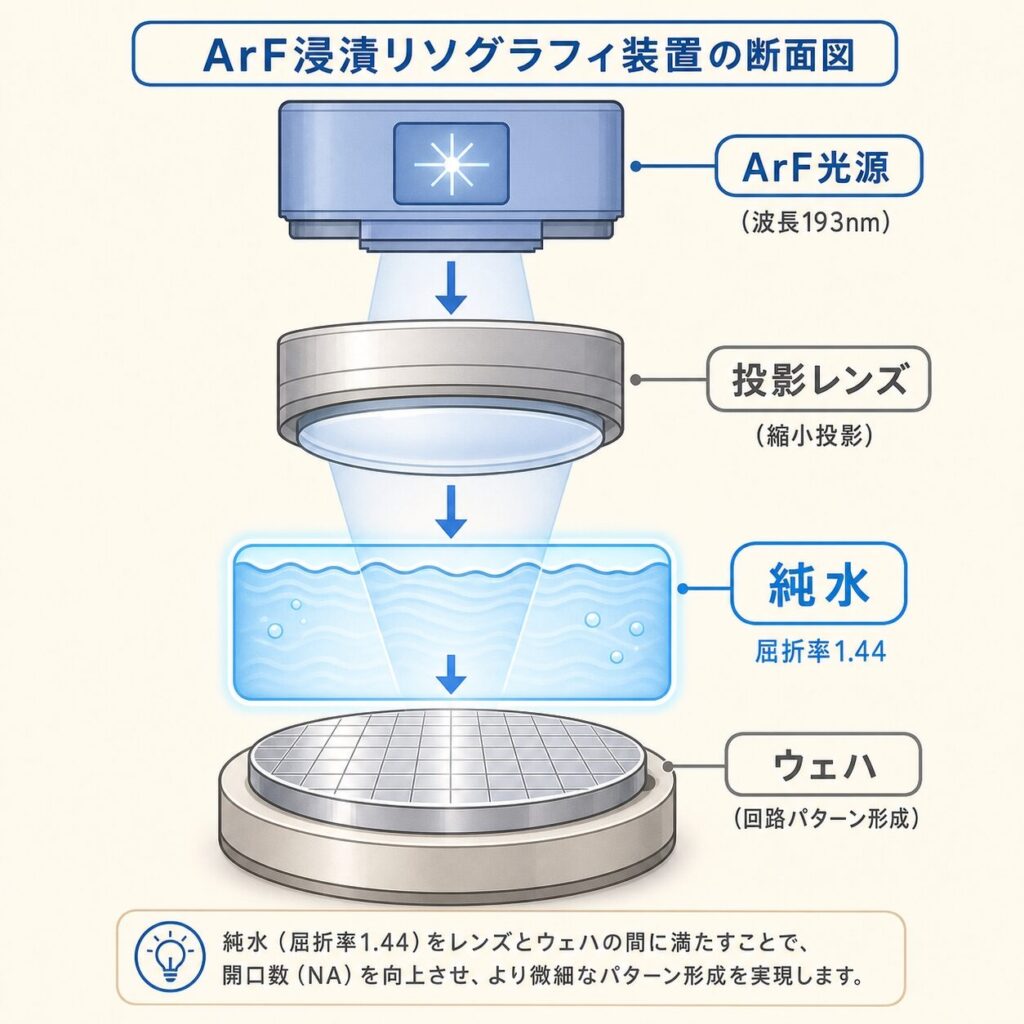
EUV時代でもArF液浸が主役を続ける3つの理由
「EUVが量産投入されたから、ArF液浸はもう古い」と思いがちですが、実態はまったく違います。2024年でも新規ArF液浸装置が販売され続けているのは、明確な理由があります。
ArF液浸の単層解像度は約38nmが限界ですが、マルチパターニング(複数回露光)を併用することで、実質的に7nm・5nm世代まで対応できます。日経の解説によれば、SMICもこの手法で7nmクラスを実現しました。詳しくはシリーズ第6回で解説します。
EUV装置1台200億円超に対し、ArF液浸装置は1台数十億円(数値は業界推定)。1チップあたりの製造コストでも、EUV適用層は限定的にとどめ、多くの層をArF液浸+マルチパターニングで処理するのが経済合理的です。
車載・産業用・パワー半導体・MCUなど、最先端でなくていい用途は世界に山ほどあります。むしろAIによる電力需要急増で、これらの「成熟ノード半導体」も需要が増加。ArF液浸はこのレイヤーを支える基幹装置です。
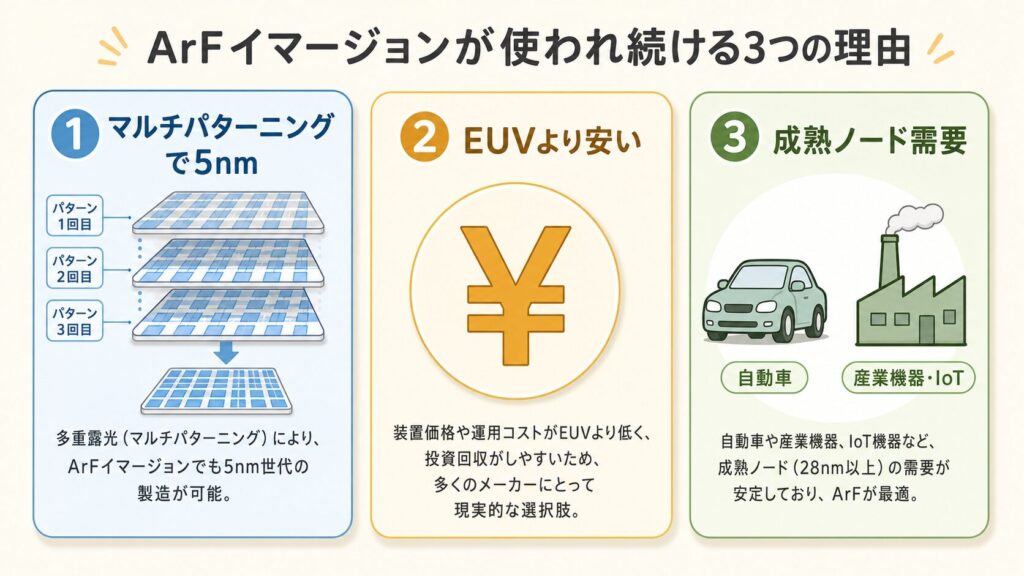
ニコンとASMLの開発競争史──なぜここで勢力が逆転したのか
実はArF液浸の「水を挟む」コンセプトを最初に実証したのはニコンでした。NEDOウェブマガジンによれば、ニコンは2003〜2004年頃に試作機で134nm相当の解像力を実証し、液浸の道を業界に示した先駆者です。しかし量産装置の商用化レースでは、ASMLが先行を許しませんでした。
📅 ArF液浸の主要マイルストーン
純水を満たした試作機で「134nm相当」の解像を業界に示す。
日経クロステックの報道によれば、ASMLは2005年にNA1.2の「XT:1700i」、2007年にNA1.35の「XT:1900i」で37nm解像を達成。量産対応の速度でニコンを抜く。
ASMLの「TWINSCAN NXT」シリーズが世界のロジック・メモリ製造の主力に。市場シェアでASMLが大きくリード。
日刊工業新聞・東洋経済の報道では、ニコンが2028年度にASML製マスクと互換性のあるArF液浸装置を投入予定。EUVではなくArF液浸で再起を図る戦略。
ASMLは部品の多くを外部調達するモジュール型ビジネスモデルで、量産時のサプライチェーン構築が速かった。一方ニコンはレンズ・光源・装置を自社内で完結させる垂直統合型で、量産化のスピードで劣後しました。技術ではなくビジネスモデルの差が勝敗を分けたのです。詳しくはシリーズ第9回(ASML独占の構造)で深掘りします。
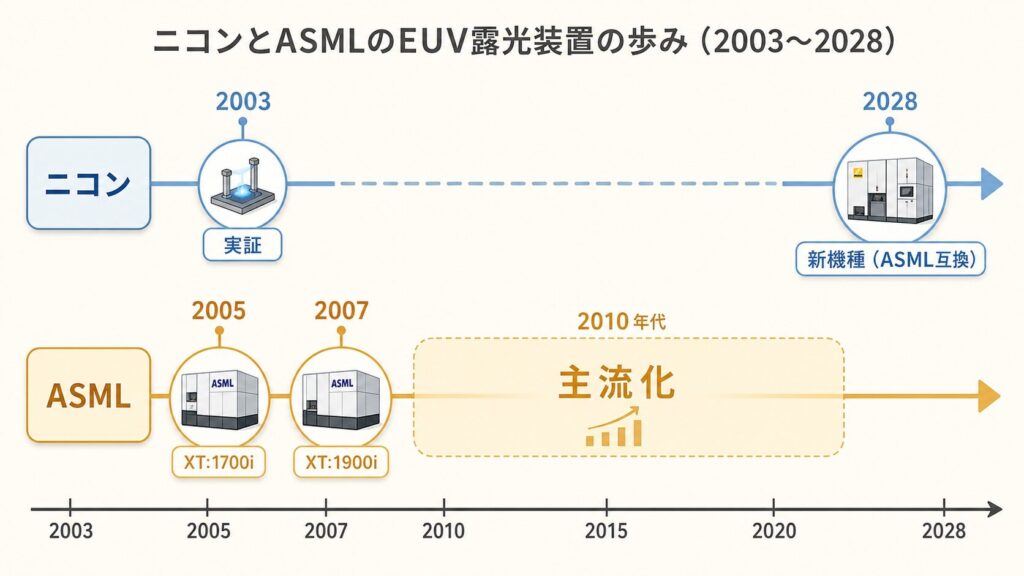
関連企業マップ──ArF液浸を支えるプレイヤー
露光装置メーカー
- ASML(ASML.AS)
市場シェアの大半/TWINSCAN NXTシリーズ - ニコン(7731)
2028年度ASML互換新製品を投入予定
光源・材料メーカー
- ギガフォトン(コマツ 6301子会社)
ArFエキシマレーザでシェア60%超(2010年実績) - Cymer(ASML子会社・米)
ArFレーザの2強の一角 - JSR(4185 ※非上場化進行中)/東京応化工業(4186)/富士フイルム(4901)
ArF液浸用レジスト
使う側(ユーザー)
- TSMC(2330.TW)
最先端+成熟ノード両方で多用 - Samsung/SK hynix/Micron(MU)
DRAM・NAND - Intel(INTC)/SMIC(中)
7nmクラスをマルチパターニングで実現
どの世代でArF液浸が現役か
※DP=ダブルパターニング、QP=クアドルプルパターニング。最先端ノードでも、配線上層など細さが要らない層では今もArF液浸が現役。
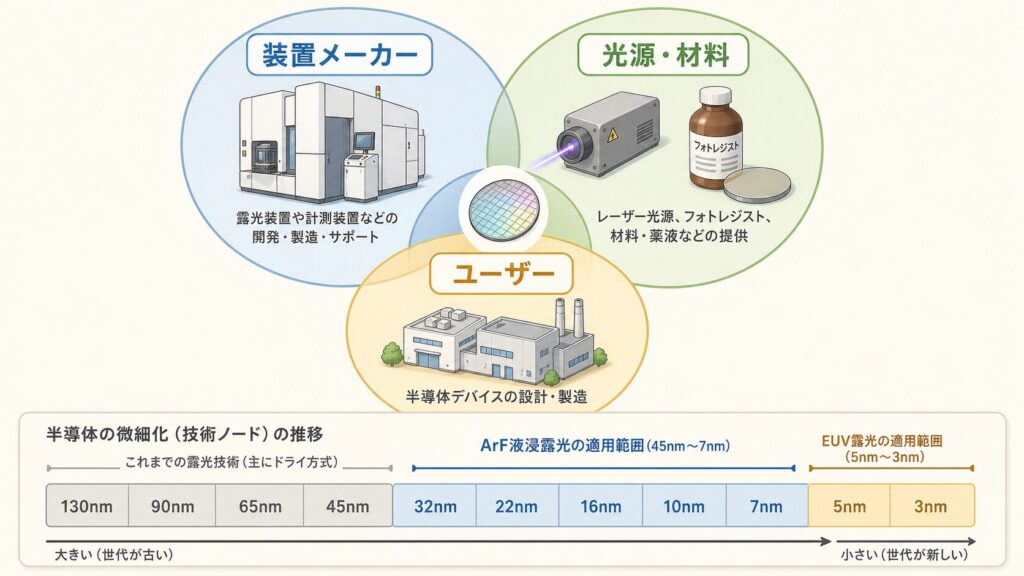
あなたにとっての意味──投資家・学生・技術者
「EUV以外は古い」という見方は大きな誤解です。ArF液浸は2030年代も現役で、車載・産業・パワー半導体の構造的需要が拡大中。ニコン(7731)の2028年度新装置投入計画は、市場が「ASML以外の選択肢」を渇望していることの表れ。EUV銘柄に偏ったポートフォリオを見直す材料になります。
ArF液浸装置は流体力学・光学・精密制御・材料化学のクロスオーバー領域。「ナノスケールの精密ステージに、水を漏らさず・気泡を作らず・温度を一定に保ちながら供給する」というのは、機械系・化学系の学生にも面白いテーマです。半導体=電気電子だけではない好例。
ArF液浸の議論で頻出する「単層解像度 vs マルチパターニング併用解像度」の区別を押さえておくと、業界ニュースの読解力が格段に上がります。「単層38nm」は物理限界、「実質7nm」はマルチパターニング込みの数字。同じ装置でも文脈で意味が変わる点に注意してください。
よくある誤解の整理
使われるのは超純水です。気泡・不純物・微粒子があれば露光精度が破綻します。さらに温度制御もmK(ミリケルビン)レベル。装置価格に「水処理システム」のコストも含まれています。
真逆です。ニコンは2028年度に新プラットフォーム投入予定、ASMLも継続的に高生産性モデルを更新中。EUVが主役になっても、ArF液浸の市場は縮小していません。
用途で異なります。EUVは最先端の細さが必要な層に、ArF液浸は大量にスループット良く処理する層に。1チップでも層によって両方使われ、上下関係ではなく役割分担です。

まとめ:ArF液浸露光の全体像
① 仕組み:ArFレーザ(193nm)とウェハの間を純水で満たし、屈折率1.44の効果で実効波長134nm相当に短縮する技術。
② 解像度向上の二重効果:波長短縮(193→134nm)+NA拡大(最大1.0→1.35〜1.4)で、解像度が大きく改善。
③ 開発史:2003〜2004年にニコンが先行実証→2007年にASMLが量産で先行→現在も両社が開発継続。
④ EUV時代でも主役:マルチパターニング併用で5〜7nm世代まで対応/装置コストが安い/成熟ノード需要が大きい。
⑤ 関連企業:装置はASML・ニコン、光源はギガフォトン(コマツ子会社)・Cymer、レジストはJSR・東京応化・富士フイルム。
❓ よくある質問(FAQ)

次に読むべき記事
| 回 | タイトル | 区分 |
|---|---|---|
| 第1回 | リソグラフィとは?「設計図を焼き付ける」工程 | 入口 |
| 第2回 | リソグラフィ光源の歴史|i線→KrF→ArF→EUV | 時系列 |
| 第3回 | 📍 ArF液浸露光とは?(この記事) | 技術 |
| 第4回 | EUVとは?13.5nmの極端紫外線 | 技術 |
| 第5回 | High-NA EUVとは?2nm世代の主役 | 次世代 |
| 第6回 | マルチパターニングとは? | 補完 |
| 第7回 | フォトマスク・レチクルとは? | 材料 |
| 第8回 | レジストとは?光で変質する薬品 | 材料 |
| 第9回 | ASMLが世界を握る理由|EUV独占の構造 | 業界 |



コメント