「フォトマスク」「レチクル」──半導体の話で何度も出てくるけど、違いを聞かれると答えに詰まる。そんな経験、ありませんか?
- フォトマスクとレチクルって、結局同じ?違うもの?
- EUVマスクは「反射型」と聞くけど、なぜ普通のマスクと違うの?
- 「ペリクル」って何?そもそも必要なの?
- HOYAやテクセンドフォトマスクが世界シェアトップらしいけど、なぜ日本企業が強いの?
- マスク1枚が数千万〜数億円する理由がわからない
- フォトマスクとレチクルの違いと現代での実質的な扱い
- EUVマスクの多層膜構造──なぜ反射型なのか
- マスクブランクス → フォトマスク → ペリクル付きの3段階
- マスクブランクス(HOYA・AGC)と描画(テクセンド・大日本印刷・Photronics)の2階層構造
- EUVマスク1枚の価格、製造の難しさ、なぜ日本が強いのか
フォトマスクとは半導体回路の「型紙」であり、レチクルはその一種(縮小投影露光用の小型版)です。現代では両者をほぼ同義で使い、特にEUV用は「EUVレチクル」「EUVマスク」と呼ばれます。EUVマスクは光を透過せず反射型──モリブデンとシリコンを40〜50層交互に積層した特殊構造を持ち、量産用1枚が4,000〜5,000万円に達します(出典:Rentec Insight)。市場は2階層に分かれ、原板(マスクブランクス)はHOYA(7741)・AGC(5201)の2社で世界シェア95%超、回路描画はテクセンドフォトマスク(429A)・大日本印刷(7912)・Photronics(PLAB)が世界寡占。日本企業がフォトマスク領域で圧倒的に強い構造を持っています。
| 回 | タイトル | 区分 |
|---|---|---|
| 第1回 | リソグラフィとは?「設計図を焼き付ける」工程 | 入口 |
| 第2回 | リソグラフィ光源の歴史|i線→KrF→ArF→EUV | 時系列 |
| 第3回 | ArF液浸露光とは? | 技術 |
| 第4回 | EUVとは?13.5nmの極端紫外線 | 技術 |
| 第5回 | High-NA EUVとは?2nm世代の主役 | 次世代 |
| 第6回 | マルチパターニングとは? | 補完 |
| 第7回 | 📍 フォトマスク・レチクルとは?(この記事) | 材料 |
| 第8回 | レジストとは?光で変質する薬品 | 材料 |
| 第9回 | ASMLが世界を握る理由|EUV独占の構造 | 業界 |
フォトマスク・レチクルとは?──「半導体の型紙」
📐 露光装置に「設計図」を渡す部品
フォトマスクとは、半導体の回路パターンを描いた石英ガラス基板です。露光装置の中にセットされ、光(ArFやEUV)をマスク越しにウェハーへ照射することで、回路パターンをウェハー上のレジストに転写します。
フォトマスクは「切り絵の型紙」のようなものです。型紙の穴を通った光だけがウェハーに当たる──型紙の通りにウェハーに模様が刻まれる。半導体1チップにつきマスクは数十〜100枚必要で、レイヤーごとに別々のマスクを使い分けます。マスクの精度がそのまま半導体の精度になるため、髪の毛の数千分の1の精度が要求されます。
欠陥を完全に除去
🤔 「フォトマスク」と「レチクル」は何が違うのか
歴史的には2つは別物でしたが、現代の最先端半導体製造ではほぼ同義として扱われます。違いを整理しましょう。
フォトマスク:ウェハー全面(または広い領域)を1回で露光する原版。等倍転写用。
レチクル:露光装置の縮小投影光学系で使う、4倍縮小の小型マスク。1ショットでチップ1個分を露光する。
最先端半導体(ArF・EUV世代)はすべて縮小投影露光のため、使われるのは厳密にはレチクル。
ただし業界では「フォトマスク」という呼び方が広く定着し、両者を区別せずに使うのが一般的。本記事でも両者を実質的に同義として扱う。
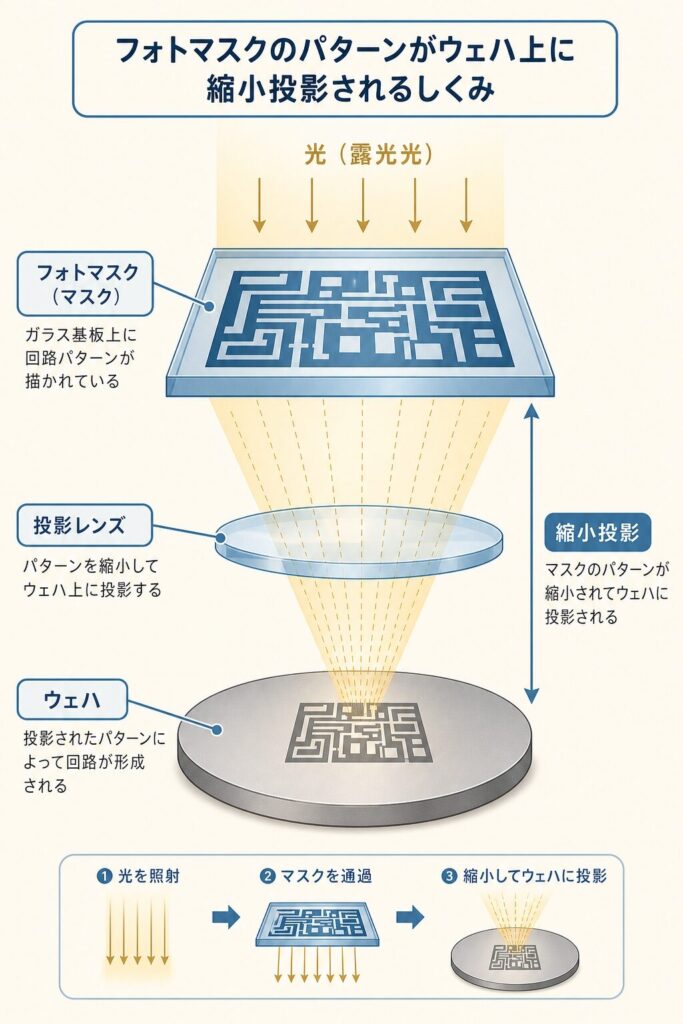
EUVマスクは「反射型」──従来とまったく違う構造
🪞 EUV光は「物質に吸収される」ため透過できない
従来のArFマスクは「透過型」──光がガラスを通り抜けて、遮光部分だけを遮ります。しかしEUV光(波長13.5nm)は、空気を含むほぼすべての物質に吸収されてしまうため、透過型のマスクが作れません。代わりにEUVマスクは「反射型」になっています。
・石英ガラス基板(透明)
・遮光膜(クロムなど)でパターン形成
・光がガラスを通過、遮光部だけ遮る
・構造がシンプル、製造容易
・低熱膨張ガラス基板+40〜50層の多層膜ミラー
・モリブデン(Mo)と シリコン(Si)の交互積層
・光を反射、吸収体(Ta系)でパターン形成
・構造が複雑、製造難度が極めて高い
🧱 EUVマスクの断面構造
EUV光を反射する「鏡」の役割
EUV光は多層膜で反射し、吸収体のあるところだけ遮られて、ウェハーに回路パターンが転写される
40〜50層のモリブデン(Mo)とシリコン(Si)の交互積層で「EUV専用の鏡」を作り、その上に吸収体(タンタル系材料)でパターンを描く──これがEUVマスクの基本構造です。多層膜の精度は原子レベルで求められ、1層でも厚みがズレれば反射率が低下します(参考:東北大学)。
フォトマスクの「原板」のこと。基板+多層膜+吸収体まで成膜された、回路パターンを描く前の状態。EUVマスクブランクスは多層膜成膜が極めて難しく、世界でHOYA(7741)とAGC(5201)の2社しか量産できない。
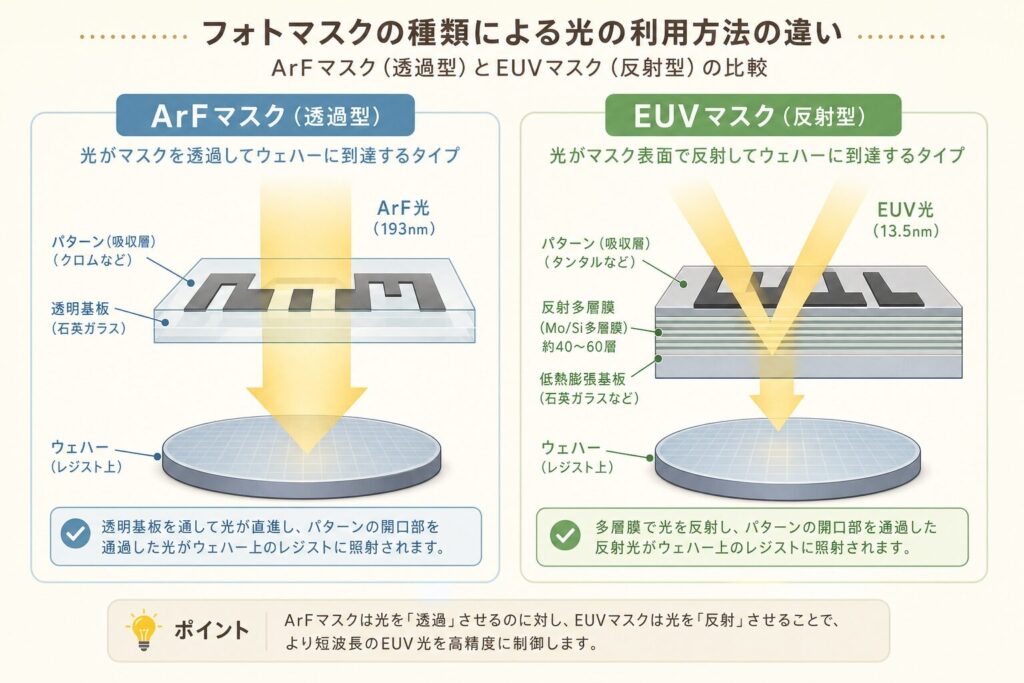
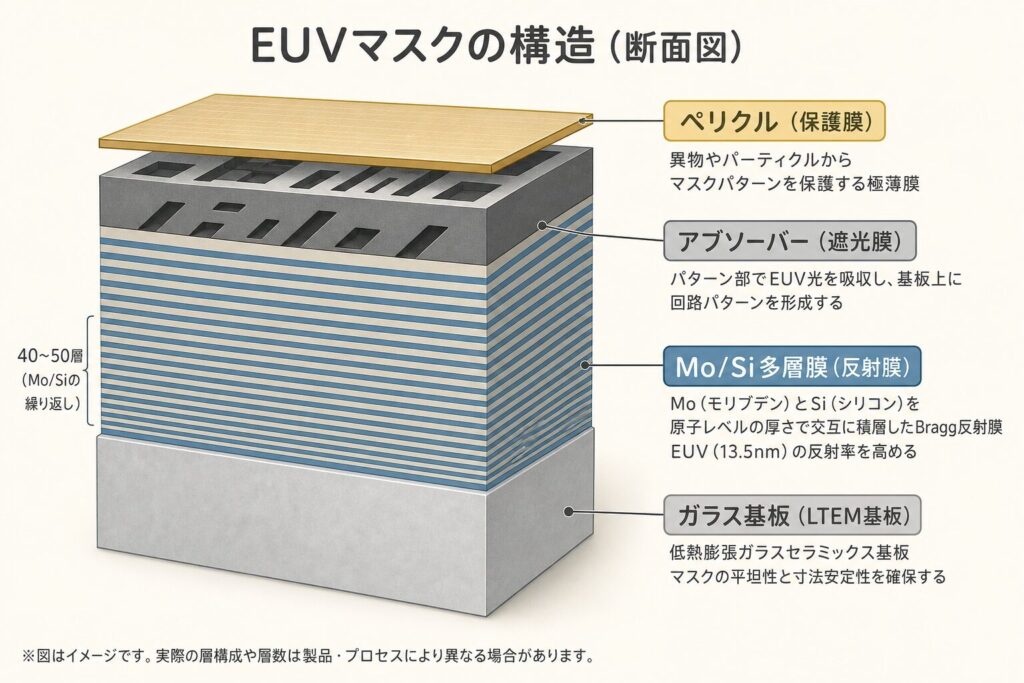
ペリクルとマスク製造の3段階
🛡️ ペリクル:マスクを守る「ラップフィルム」
ペリクル(pellicle)とは、フォトマスクの表面を覆う極めて薄い保護膜です。直接マスクに付着するゴミ・パーティクルを防ぎ、付いてもピント面から離れるためウェハーに転写されない、という二重の効果を持ちます。
ペリクルは「食品ラップ」のようなものです。皿(マスク)の表面を直接守り、ホコリが乗っても皿には届かない。問題は、EUV光がほとんどの物質に吸収されること。つまりラップを使うと光自体が弱まってしまいます。EUV用ペリクルには「EUV光を90%以上透過させる極薄膜」という難題が課されており、現在も最先端材料の開発が進んでいます(カーボンナノチューブ膜などが有望視されています)。
🏭 マスク製造の3段階
完成したフォトマスクが露光装置に届くまでには、明確な3段階の工程があります。それぞれを担う企業も異なります。
低熱膨張ガラス基板に多層膜・吸収体を成膜した「原板」を作る工程。EUV用は40〜50層のMo/Si交互積層が必要で、原子レベルの精度が求められる。HOYA(7741)・AGC(5201)の2社で世界シェア95%超。
マスクブランクス上に電子線描画装置で回路パターンを刻み込む工程。さらにレーザーテック(6920)等のマスク欠陥検査装置で完璧に欠陥を取り除く。テクセンドフォトマスク(429A)・大日本印刷(7912)・Photronics(PLAB)が世界寡占。
完成したマスクの表面にペリクル(防塵膜)を装着して出荷。EUV用ペリクルは三井化学・三菱ケミカル等が開発を進めるが、まだ完全に標準化されていない最先端領域。
「マスクブランクス(原板製造)」と「フォトマスク(描画・検査)」は別の市場・別の企業群です。投資で混同しないように注意。HOYAとAGCはマスクブランクス(原板)、テクセンド・大日本印刷・Photronicsはフォトマスク(描画)。両方とも世界シェア上位を日本企業が占めるのがフォトマスク産業の構造です。
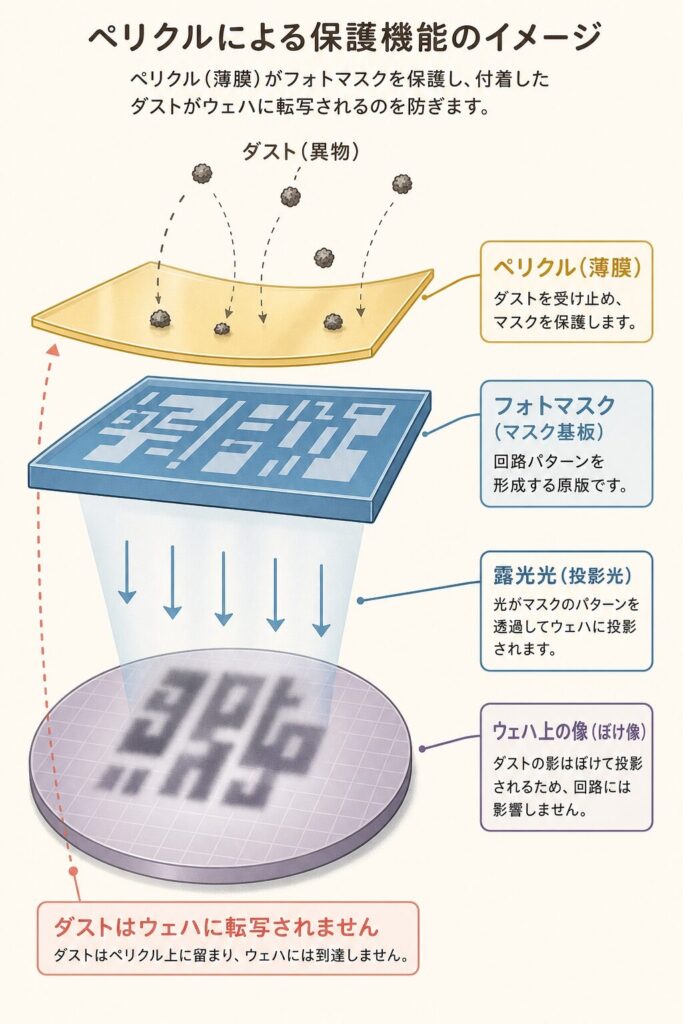
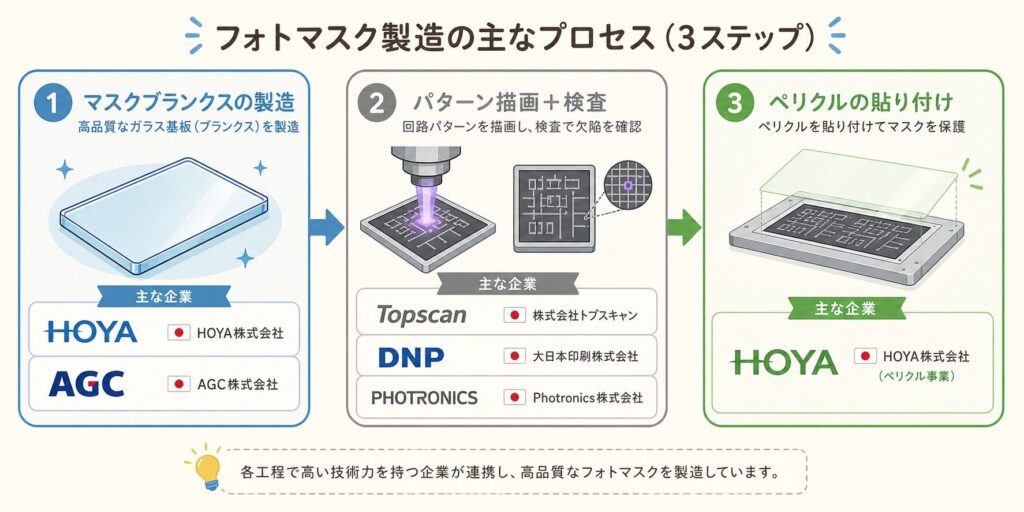
関連企業マップ──日本が世界寡占を握る理由
🇯🇵 マスクブランクス+描画+検査の3層で日本が強い
マスクブランクス(原板)
- HOYA(7741)
EUVマスクブランクス世界トップ - AGC(5201)
世界2位、HOYAと2社で95%超 - 信越化学(4063)
合成石英基板で材料側を支える
(2024年・QYResearch)
フォトマスク(描画)
- テクセンドフォトマスク(429A)
外販で世界シェア約39%、TOPPAN系で2025年上場 - 大日本印刷(DNP)(7912)
日本を代表する寡占プレイヤー - Photronics(PLAB)
米国の世界2位プレイヤー - SK-Electronics(韓国)
マスク検査・関連
- レーザーテック(6920)
EUVマスク欠陥検査装置で世界独占 - KLA(KLAC)
マスク検査の米国大手 - 三井化学(4183)、三菱ケミカル(4188)
EUVペリクル材料
💴 マスク1枚の価格──「EUVだけが特別に高い」
数千万円
5,000万円
十数億円
出典:従来マスク・EUVマスク量産用は Rentec Insight、最先端マスクは マスク欠陥検査装置業界分析 を参考に構成
半導体1チップを作るのにマスクは数十〜100枚必要で、最先端ロジックならマスクセット全体で数十億円になります。これがファブレス企業(NVIDIA・AMDなど)にとってマスク代が大きな初期投資になる理由です。
フォトマスクは「ASML一強・装置だけ買えばいい」ではない、日本企業が世界寡占を握る数少ない領域です。HOYA・AGC(マスクブランクス)、テクセンドフォトマスク・大日本印刷(フォトマスク描画)、レーザーテック(マスク検査)──いずれも事業の構造的優位性が極めて高い。EUV普及・High-NA EUV普及でマスク需要・マスク単価ともに上昇する追い風構造です。
フォトマスク領域は材料工学・薄膜技術・電子線描画・光学・ナノ計測すべてが交わる工程。HOYA・AGC(材料系)、テクセンド・大日本印刷(精密技術)、レーザーテック(計測技術)──理工系のキャリアパスとして日本国内で世界トップを目指せる稀有な領域です。

よくある誤解を整理する
| ❌ よくある誤解 | ✅ 実際はこう |
|---|---|
| 「フォトマスクとレチクルは別物」 | 古典的には別物だったが、現代の最先端半導体ではほぼ同義。最先端は全て縮小投影露光なので、厳密にはレチクルだが、業界では「フォトマスク」と呼ぶことが多い。 |
| 「EUVマスクはArFマスクの強化版」 | 構造が根本的に異なる。ArFは透過型、EUVは反射型。Mo/Si多層膜という従来にない構造のため、マスクブランクス製造は世界2社(HOYA・AGC)の独占となっている。 |
| 「ペリクルはあると邪魔」 | ペリクルがないと、マスク表面についたゴミ1個でチップ全体が不良になる。歩留まりを支える必須部品。EUV用は光透過率の確保が難しく、最先端材料領域として注目される。 |
| 「マスク産業は1社が独占している」 | 2階層構造。マスクブランクス(原板)はHOYA・AGCの2社で95%超、フォトマスク(描画)はテクセンド・大日本印刷・Photronicsで世界寡占。装置メーカーとは別の市場。 |
| 「マスク代は安い」 | EUV量産マスク1枚で4,000〜5,000万円、最先端は数億円も。半導体1チップ製造に数十〜100枚必要で、マスクセット全体で数十億円規模になる。 |

まとめ:フォトマスク・レチクルを5点で整理する
① 定義:フォトマスク=半導体回路の「型紙」。レチクルは縮小投影用の小型版。最先端半導体ではほぼ同義として扱う。
② EUVマスクは反射型:EUV光が物質を透過しないため、Mo/Si 40〜50層の多層膜ミラー構造。原子レベルの精度が必要。
③ ペリクル:マスク表面を守る防塵膜。EUV用は光透過率を確保しつつ薄膜化する難題。
④ 製造の3段階:マスクブランクス(HOYA・AGC)→ パターン描画(テクセンド・DNP・Photronics)→ ペリクル装着。
⑤ 価格:従来マスクは数百万〜数千万円、EUV量産マスクは4,000〜5,000万円、最先端は数億〜十数億円。1チップで数十枚必要。
結局こういうことです。フォトマスクは「半導体の型紙」であり、その精度がチップの精度を決めます。EUV時代に入って構造が反射型に進化し、製造難度は飛躍的に上がりました。そして注目すべきは、マスクブランクス(HOYA・AGC)と描画(テクセンド・大日本印刷)のいずれも日本企業が世界シェア上位を占めること。「ASML一強」のEUV装置とは異なり、フォトマスク領域は日本企業が構造的優位を維持している、貴重な領域です。
❓ よくある質問(FAQ)
次に読むべき記事
マスクを理解したら、次は「光が当たって反応する側」のレジストへ。マスクと対をなす材料領域です。
📚 リソグラフィ完全シリーズ(全9記事)── 詳細版
リソグラフィシリーズは全9記事の体系的な学習ロードマップです。順番に読むと「光をどう半導体に焼き付けるか」の全体像が掴めます。
| 第1回 |
リソグラフィとは?「設計図を焼き付ける」工程
シリーズの入口。半導体製造で最も重要な「露光」の全体像
|
| 第2回 |
リソグラフィ光源の歴史|i線→KrF→ArF→EUV
なぜ波長を短くしてきたのか。50年の進化を時系列で
|
| 第3回 |
ArF液浸露光とは?
水を使って解像度を上げる発想の転換。EUV以前の主役
|
| 第4回 |
EUVとは?13.5nmの極端紫外線
7nm以細の世代に必須の技術。仕組み・装置・現状を解説
|
| 第5回 |
High-NA EUVとは?2nm世代の主役
NA0.55の次世代装置。Intel 14Aで業界初の量産導入へ
|
| 第6回 |
マルチパターニングとは?
LELE/SADP/SAQPで微細化を実現する「力技」の真髄
|
| 第7回 |
📍 フォトマスク・レチクルとは?(この記事)
日本企業が世界寡占を握る半導体「型紙」の全貌
|
| 第8回 |
レジストとは?光で変質する薬品
JSR・東京応化・信越化学・富士フイルムの世界寡占構造
|
| 第9回 |
ASMLが世界を握る理由|EUV独占の構造
シリーズの締め。なぜASML一強が崩れないのかを業界構造で解説
|
📩 記事の更新情報を受け取りたい方へ
新しい記事が公開されたら、Xアカウント @shirasusolo でお知らせします。半導体プロセスの構造を一緒に学んでいきましょう。

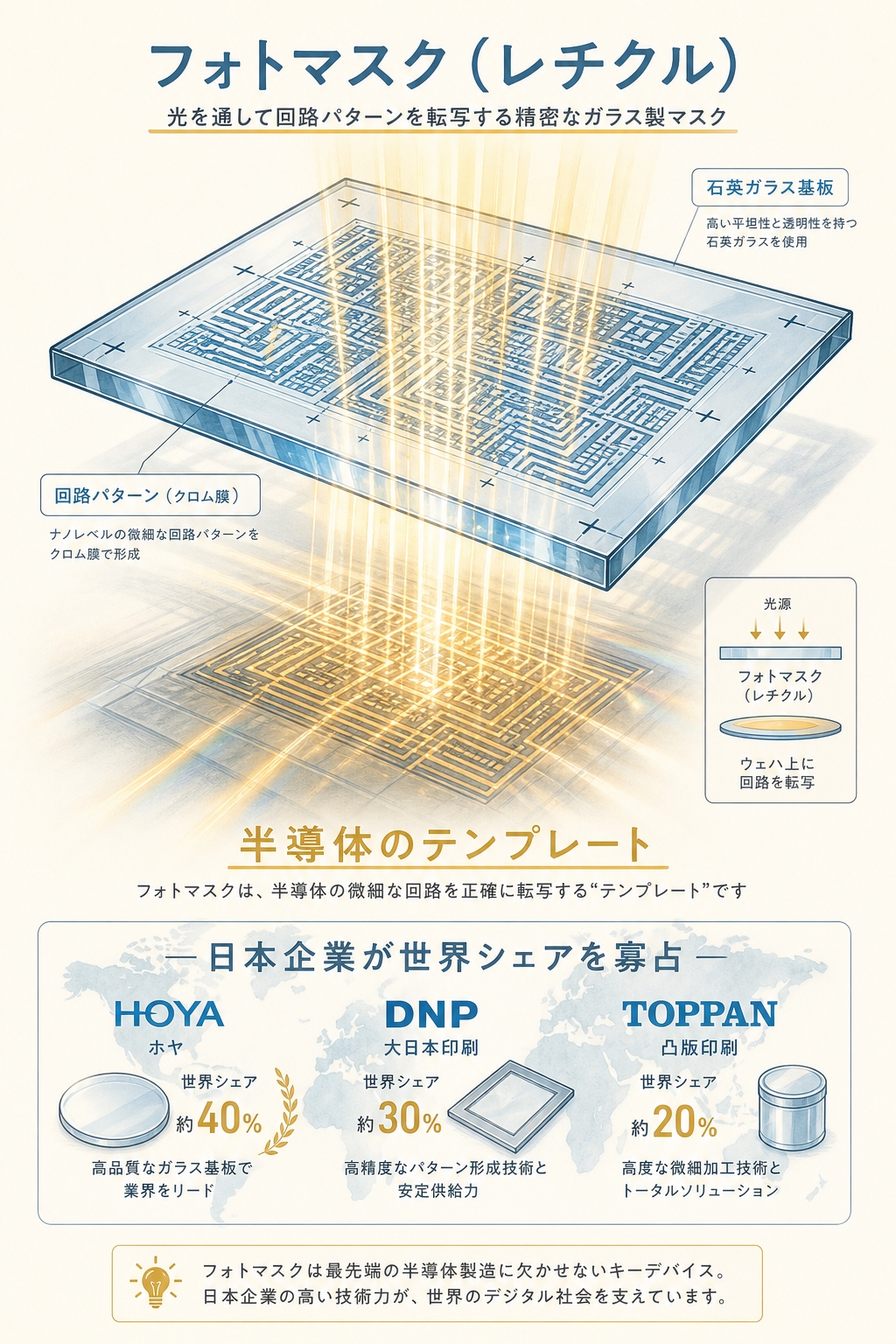

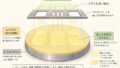
コメント