「マルチパターニング」──EUVと並んで聞くこの言葉、なんとなくスルーしていませんか?
- EUVとマルチパターニングはどっちが先で、どう違うの?
- LELE・SADP・SAQPって何の略?覚えられない
- 「TSMCはA14でEUVマルチパターニングを使う」って報道、何を意味する?
- 装置を変えないのに、なぜ細い線が描けるの?
- マルチパターニングの定義と「力技」と呼ばれる理由
- 3つの主要方式(LELE / SADP / SAQP)の違いを図解
- 露光1回で2倍・4倍の解像度を実現する幾何学的トリック
- EUVとマルチパターニングの代替・併用の関係
- TSMC・Intel・Micronの採用判断と関連企業
マルチパターニングとは、1回の露光では描けない微細パターンを、複数回の露光や追加プロセスを組み合わせて実現する技術の総称です。代表的な方式にLELE(露光2回)、SADP(自己整合ダブル)、SAQP(自己整合クアドラプル)の3つがあります。装置を高価なEUVに買い替えなくても、既存のArF液浸露光で微細化を進められる「力技」のアプローチ。TSMCはA14(1.4nm世代)で従来EUV+マルチパターニングを継続採用、Micronも「現時点では避けられない」と表明。EUV普及後も消えるどころか、むしろ EUV と組み合わせて使われ続ける──それがマルチパターニングの現在地です。
| 回 | タイトル | 区分 |
|---|---|---|
| 第1回 | リソグラフィとは?「設計図を焼き付ける」工程 | 入口 |
| 第2回 | リソグラフィ光源の歴史|i線→KrF→ArF→EUV | 時系列 |
| 第3回 | ArF液浸露光とは? | 技術 |
| 第4回 | EUVとは?13.5nmの極端紫外線 | 技術 |
| 第5回 | High-NA EUVとは?2nm世代の主役 | 次世代 |
| 第6回 | 📍 マルチパターニングとは?(この記事) | 補完 |
| 第7回 | フォトマスク・レチクルとは? | 材料 |
| 第8回 | レジストとは?光で変質する薬品 | 材料 |
| 第9回 | ASMLが世界を握る理由|EUV独占の構造 | 業界 |
マルチパターニングとは?──「1回で描けないなら、何回かに分けて描く」
🎨 露光1回の解像限界を、回数と工夫で突破する
半導体露光には「1回の露光で描ける線幅」に物理的な限界があります。たとえばArF液浸露光(波長193nm)は、単純な1回露光では約38nmが限界。これより細い線を描こうとしても、光の回折で滲んでしまい、隣の線とくっついてしまいます。
この限界を突破する技法がマルチパターニングです。「1回で描けないなら、複数回に分けて描く」「光で描けないなら、薄膜の幾何学を使う」──こうした工夫で、装置の物理限界を超えた微細パターンを実現します。
or スペーサ法
マルチパターニングは「太いマジックペンで細い縞模様を描く」発想です。1回で描くと線が太すぎて隙間が潰れる。でも、まず黒で線を描いて、次に隣のスペースに白で線を描けば、結果として「2倍細かい縞模様」が現れます。これがLELE。さらに「線の縁に薄い側壁を貼り付ける」発想がSADP。「これしかない」というよりは「物理的な解像限界を、人間の創意工夫で突破した」歴史的成果です。
半導体に回路パターンを形成する一連の工程。露光・現像・エッチングを組み合わせて、ウェハー上に設計図通りの形を刻む。「マルチパターニング」とは、これを1ループで終わらせず、複数ループ繰り返すこと。

3つの主要方式──LELE・SADP・SAQPの違い
マルチパターニングの代表的な方式は3つ。略語が多くて混乱しがちですが、「分け方」と「何倍細かくなるか」の2軸で整理すると一気に理解できます。
🎨 方式①:LELE(Litho-Etch-Litho-Etch)── 露光2回で2倍細かく
LELE(レレ)は最もシンプルな方式です。「露光→エッチング」を2回繰り返し、2枚のマスクで半分ずつパターンを描いて重ねます。1回目で奇数本目の線を、2回目で偶数本目の線を描く──結果として、1回露光の2倍細かいパターンが完成します(参考:Semi journal)。
さらに進化させたのがLELELE(露光3回)。マスクを3枚に分け、3倍細かくします。ただし露光回数が増えるほど、コスト・歩留まり・マスクの位置合わせ精度(オーバーレイ)の要求が指数関数的に厳しくなります。
🪞 方式②:SADP(Self-Aligned Double Patterning)── スペーサで2倍
SADP(サドプ)は、露光1回しか行いません。代わりに「スペーサ(側壁)」という幾何学的トリックを使います。
露光で「マンドレル」と呼ばれる柱状パターンを形成
マンドレルの両側面に薄膜(スペーサ)を均一に成膜(ALDで原子層レベルの厚さ制御)
エッチングでマンドレルを除去 → スペーサだけが残る
マンドレル1本につきスペーサ2本が残る → パターン密度が2倍に
SADPの強みは「自己整合(Self-Aligned)」──スペーサの位置がマンドレルから自動的に決まるため、LELEのような露光間オーバーレイ誤差が生じません。3D NANDフラッシュやFinFETのフィン形成で広く使われています。
🔁 方式③:SAQP(Self-Aligned Quadruple Patterning)── スペーサを2回で4倍
SAQP(サキューピー)は、SADPを2回繰り返す方式です。まずSADPでパターン密度を2倍に。次にできたパターンをマンドレルとして、もう一度スペーサを形成。合計4倍の密度を実現します。
SAQPは10nm世代以降のフィン形成や、3D NANDの最先端世代で必須です。ただし工程数が多く、装置占有時間も長いため、コストはSADPの2倍以上になります。
📊 LELE / SADP / SAQP の比較
| 方式 | 仕組み | 解像度 | マスク枚数 | 主な用途 |
|---|---|---|---|---|
| LELE | 露光×2回 | 2倍 | 2枚 | 配線層、ロジックの一部 |
| SADP | 露光×1回+スペーサ | 2倍 | 1枚 | FinFETフィン、3D NAND |
| SAQP | SADP×2回 | 4倍 | 1枚 | 10nm以細フィン、最先端3D NAND |
出典:方式定義は Semiconductor Engineering、東京エレクトロン技報、用途は PC Watch を参考に構成
LELEは2回の露光間でマスク位置合わせ(オーバーレイ)誤差が累積します。一方SADP/SAQPは1回の露光から幾何学的にパターンを増やすため、誤差が原理的に発生しません。微細化が進むほど、SADP/SAQPの優位性が高まります。
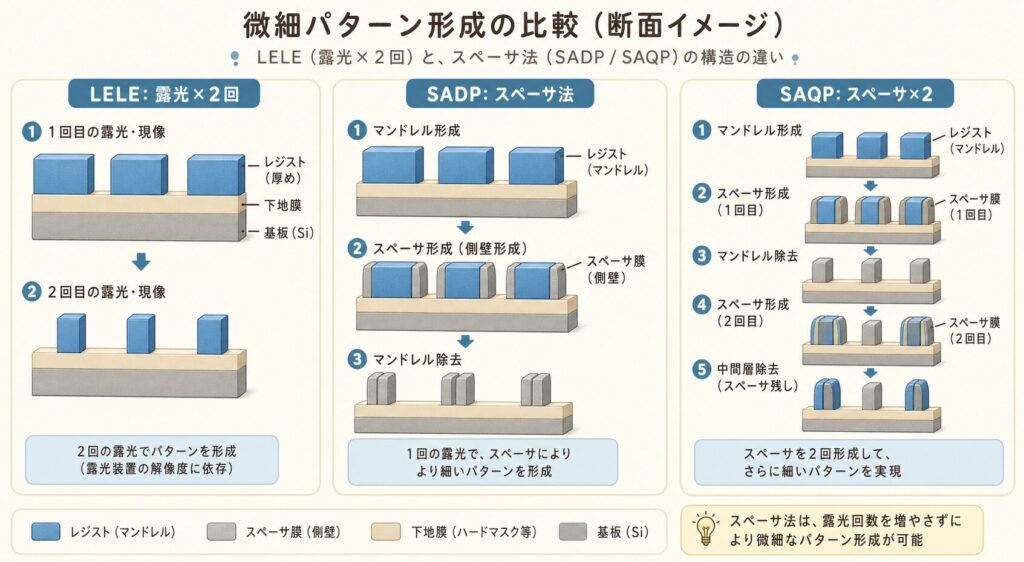
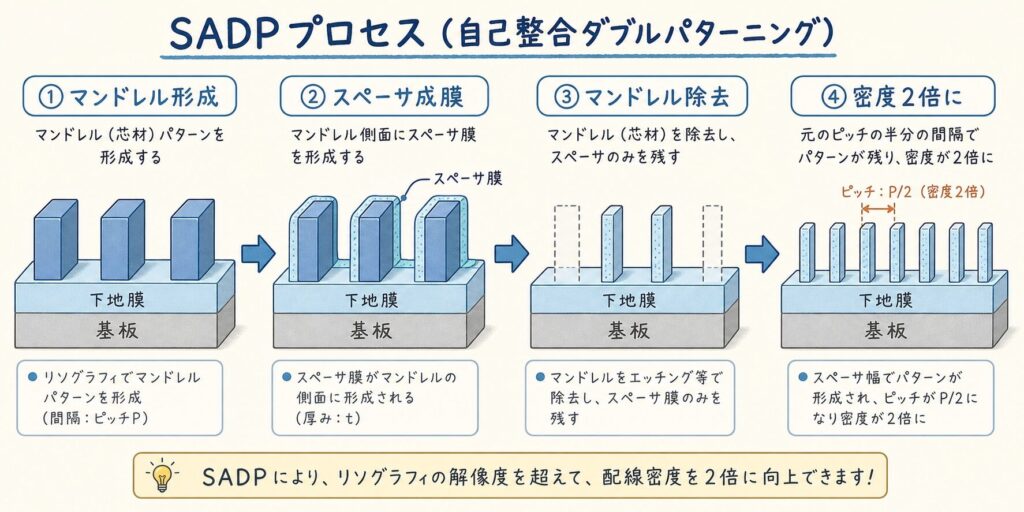
EUVとマルチパターニングは「敵」ではなく「相棒」
🤝 EUV普及後も、マルチパターニングは消えていない
「EUVが登場したから、マルチパターニングは不要になった」──これが最大の誤解です。実際にはEUV普及後も、マルチパターニングは消えるどころか、むしろEUVと組み合わせて使われ続けています。
EUVが使えない世代・用途ではマルチパターニングで代替。
・中国SMICはEUV禁輸のため7nm相当をDUV+SAQPで実現
・TSMCはA14でHigh-NA EUVを見送り、従来EUV+マルチパターニングを選択
・コスト重視の世代では装置投資を抑えるため
EUVを使う世代でも、EUVマルチパターニングとして併用。
・3nm以細では1回EUV露光でも限界に到達
・EUVダブルパターニングで実効解像度をさらに向上
・Micronは「マルチパターニングは現時点で避けられない」と表明
TSMCのA14(1.4nm世代)戦略は象徴的です。同社は2028年量産予定のA14で、High-NA EUVを採用せず、従来のNA0.33 EUV+マルチパターニング+計算リソグラフィの組み合わせで対応する方針を発表しました(出典:XenoSpectrum)。1台4億ドルのHigh-NA EUVを大量導入するより、既存EUVを徹底的に使い倒すほうが合理的という判断です。
「EUVがあればマルチパターニングは不要」は10年前のロードマップの話です。現実には、EUV普及後もマルチパターニングは併用され続け、SAQPやEUVダブルパターニングという形で進化を続けています。「ASML一強だから装置メーカーは儲からない」という見方も、SAQPに必要なALD装置・成膜装置・エッチング装置を作る東京エレクトロン(8035)・LAM Research(LRCX)・AMAT(AMAT)の存在を見落としています。

マルチパターニングの関連企業と意味
🏭 装置・材料・ユーザーの3面マップ
マルチパターニングは「ASML独占」ではなく、多くの装置・材料メーカーが関わる領域です。これがEUVと決定的に異なる構造です。
装置メーカー
- 東京エレクトロン(8035)
コータ/デベロッパ、エッチング、ALD装置 - LAM Research(LRCX)
エッチング・成膜の世界2強 - Applied Materials(AMAT)
ALD・PVD・エッチング - ASML(ASML.AS)
露光装置(DUV/EUV)と計算リソグラフィ
材料・部品メーカー
- JSR(4185 ※非上場化進行中)、東京応化工業(4186):
マルチパターニング用レジスト - 信越化学(4063)、富士フイルム(4901)
:スペーサ材料・ハードマスク - レゾナック(4004):
SOC(スピンオンカーボン)等
使う側(ユーザー)
- TSMC(2330.TW):
A14でEUV+マルチパターニング - Intel(INTC):
従来世代でSAQP活用 - Samsung Foundry(005930.KS)
- Micron(MU)、SK Hynix(000660.KS):
DRAM・NANDで多用 - SMIC(0981.HK):
EUV代替の主力技術
🎯 あなたにとっての意味
「ASML独占=他装置メーカーは斜陽」と早合点しないでください。マルチパターニングが続く限り、SAQPに必要なALD・成膜・エッチング装置の需要は構造的。東京エレクトロン(8035)・LAM Research(LRCX)・Applied Materials(AMAT)はEUV普及後もむしろ追い風を受けます。さらに、計算リソグラフィの重要性が増すなかでASML子会社Brionの位置も注目に値します。
マルチパターニングは幾何学・物理化学・薄膜工学・流体力学・統計すべてが交わる工程です。「露光屋」ではなく「成膜屋」「エッチング屋」「材料屋」が活躍する領域。化学・材料・機械系の学生にとって、東京エレクトロン・信越化学・JSRなど日本企業への就職と直結します。
マルチパターニングはプロセス工程数を倍増させ、装置稼働率・歩留まり管理の難易度を一段引き上げます。1ロットあたりの露光・成膜・エッチング回数が増えるほど、装置間のコンタミ管理・搬送制御・統計解析の重要性が増します。製造現場の技術者にとって、最も価値が出る領域の一つです。
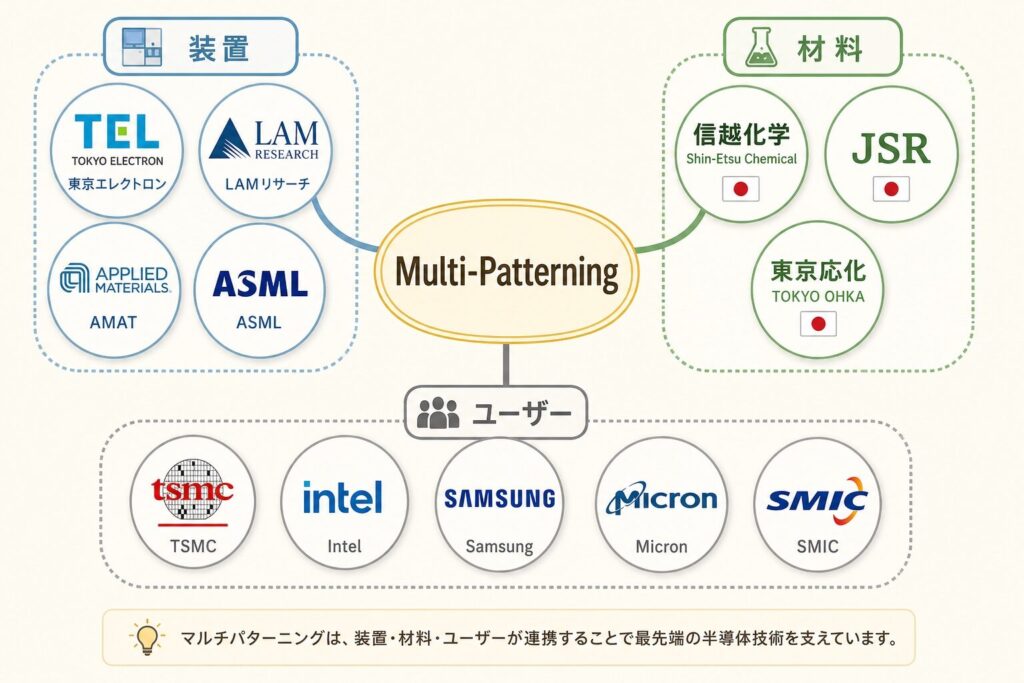

よくある誤解を整理する
| ❌ よくある誤解 | ✅ 実際はこう |
|---|---|
| 「EUVが普及したらマルチパターニングは不要」 | EUV普及後もマルチパターニングは継続。3nm以細ではEUVダブルパターニングとして併用される。Micronも「現時点で避けられない」と公式表明。 |
| 「LELEとSADPはほぼ同じ」 | 仕組みが根本的に異なる。LELEは露光2回(オーバーレイ誤差が累積)、SADPは露光1回+幾何学(自己整合で誤差なし)。SADPのほうが微細化に有利。 |
| 「マルチパターニングは安い代替手段」 | 露光装置の追加投資は不要だが、工程数・マスク数・装置占有時間が大幅に増える。SAQPはコスト的にEUVを上回るケースもある。「安い」かどうかは世代と用途次第。 |
| 「中国だけが使う技術」 | TSMC・Intel・Samsung・Micron全社が活用。EUV禁輸の中国はSAQPに依存度が高いだけで、業界全体で標準的に使われる。 |
| 「装置メーカー=ASMLしか得しない」 | マルチパターニングの恩恵は東京エレクトロン・LAM・AMATなどALD・エッチング装置メーカーに大きく波及。日本企業も追い風を受ける構造。 |
まとめ:マルチパターニングを5点で整理する
① マルチパターニングとは:1回の露光で描けない微細パターンを、複数回の露光や薄膜の幾何学で実現する技術の総称。
② 3つの方式:LELE(露光2回で2倍)、SADP(露光1回+スペーサで2倍)、SAQP(SADP×2回で4倍)。
③ SADP/SAQPの強み:「自己整合」により露光間オーバーレイ誤差が原理的に発生しない。10nm以細の主役。
④ EUVとの関係:EUV普及後も消えず、むしろ併用される。TSMCはA14でEUV+マルチパターニングを選択。
⑤ 関連企業:東京エレクトロン・LAM・AMAT(装置)、信越化学・JSR・東京応化(材料)が広く関わる。ASMLだけが恩恵を受けるわけではない。
結局こういうことです。マルチパターニングは「EUVが間に合わなかった時代のつなぎ」ではありません。装置の物理限界を、人間の幾何学的な創意工夫で突破した歴史的成果であり、EUV時代の今もなお、半導体微細化の主役技術として進化を続けています。「露光だけが微細化を決めない」──この事実こそ、半導体プロセスの奥深さを象徴しています。
❓ よくある質問(FAQ)
次に読むべき記事
マルチパターニングを理解したら、次はその「型」となるフォトマスクへ。マルチパターニングはマスクを複数枚使うため、マスク技術の理解が次のステップです。
マルチパターニングの「対」となる選択肢。Intel 14AはHigh-NA EUV、TSMC A14はマルチパターニング──判断分岐の理由。
📚 リソグラフィ完全シリーズ(全9記事)── 詳細版
リソグラフィシリーズは全9記事の体系的な学習ロードマップです。順番に読むと「光をどう半導体に焼き付けるか」の全体像が掴めます。
| 第1回 |
リソグラフィとは?「設計図を焼き付ける」工程
シリーズの入口。半導体製造で最も重要な「露光」の全体像
|
| 第2回 |
リソグラフィ光源の歴史|i線→KrF→ArF→EUV
なぜ波長を短くしてきたのか。50年の進化を時系列で
|
| 第3回 |
ArF液浸露光とは?
水を使って解像度を上げる発想の転換。EUV以前の主役
|
| 第4回 |
EUVとは?13.5nmの極端紫外線
7nm以細の世代に必須の技術。仕組み・装置・現状を解説
|
| 第5回 |
High-NA EUVとは?2nm世代の主役
NA0.55の次世代装置。Intel 14Aで業界初の量産導入へ
|
| 第6回 |
📍 マルチパターニングとは?(この記事)
LELE/SADP/SAQPで微細化を実現する「力技」の真髄
|
| 第7回 |
フォトマスク・レチクルとは?
露光の「型」となる重要部品。日本企業が強い領域
|
| 第8回 |
レジストとは?光で変質する薬品
JSR・東京応化・信越化学・富士フイルムの世界寡占構造
|
| 第9回 |
ASMLが世界を握る理由|EUV独占の構造
シリーズの締め。なぜASML一強が崩れないのかを業界構造で解説
|
📩 記事の更新情報を受け取りたい方へ
新しい記事が公開されたら、Xアカウント @shirasusolo でお知らせします。半導体プロセスの構造を一緒に学んでいきましょう。
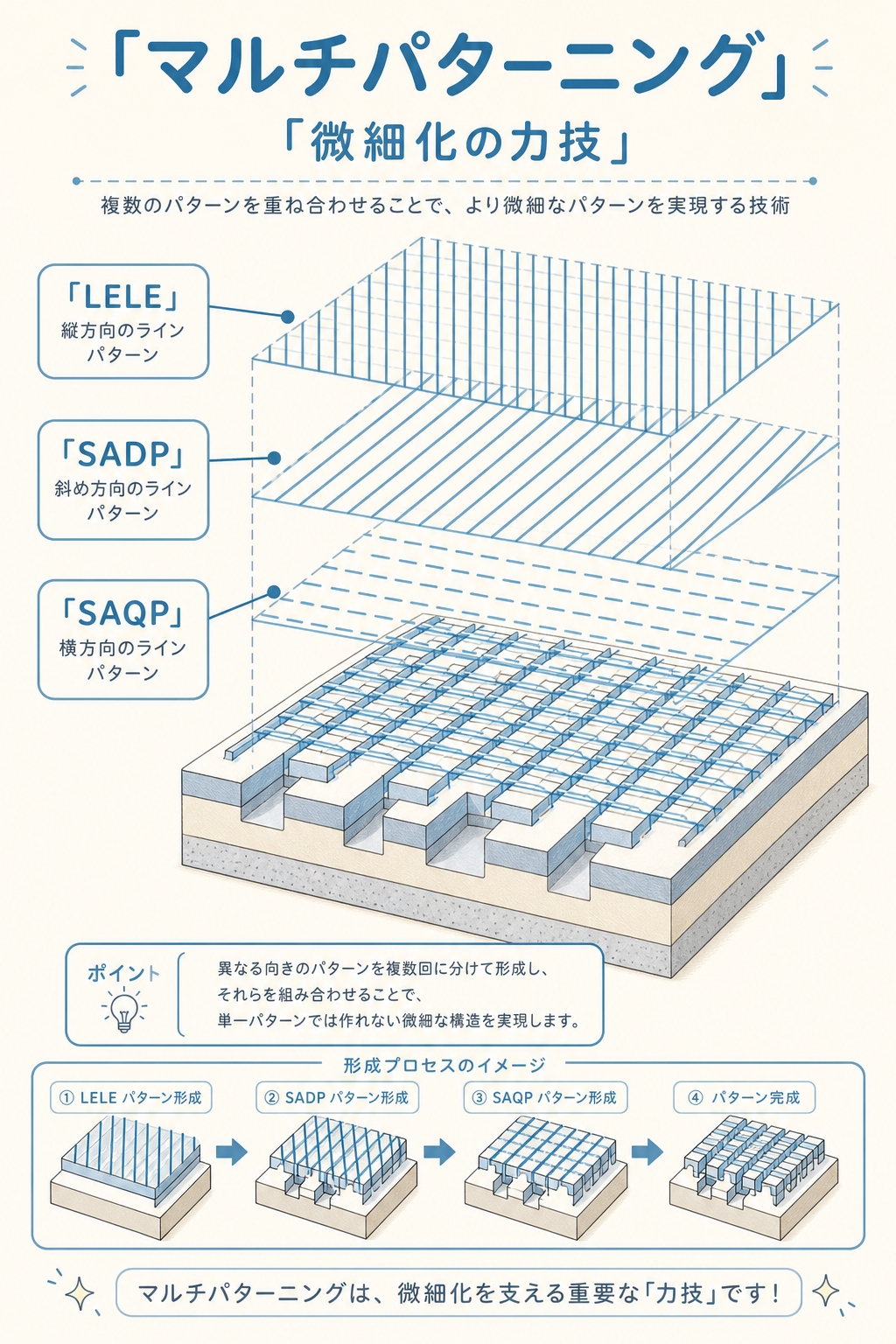


コメント