「ALD」──AI半導体の話題で急に注目度が上がっているこの技術、こんなふうに感じていませんか?
- 「原子1層ずつ積む」って、本当に1層ずつ?
- CVDと何が違うの? なぜALDが必要?
- GAA・HBM・3D NANDで「ALDが急成長」と聞くが、なぜ?
- ASMインターナショナルってどんな会社? 日本企業はどこが強い?
- ALDの仕組み──「自己制御反応」とは何か
- CVDとの決定的な違いと精度の桁違いさ
- AI半導体時代にALDが急成長する構造
- 装置メーカー(ASM International・東京エレクトロン・Lam・KOKUSAI ELECTRIC)の競争マップ
ALD(Atomic Layer Deposition:原子層堆積)とは、原子1層分(数Å=0.数nm)の膜を、1サイクルずつ積み重ねていく超精密成膜技術です。CVDのように「ガスを混ぜて反応させる」のではなく、原料Aと原料Bを交互に流して、表面でだけ反応させる「自己制御」がALDの魔法。これにより、ナノスケールの凹凸にもむらなく均一に膜を作れます。AI半導体時代のGAAトランジスタ・3D NAND・HBM・High-k絶縁膜では、もはやALDなしでは作れません。市場規模は2024年の約62億ドルから2033年に約148億ドル(CAGR約11%)へ急成長する見通し。装置市場ではASMインターナショナル(ASMI)が単一ウェーハ型で世界シェア55%以上、KOKUSAI ELECTRIC(6525)がバッチ型で世界シェア約7割と、得意領域で住み分けが進んでいます。

ALDとは?──「原子1層ずつ」を実現する自己制御反応
🧬 一言でいうと「原子1層を、サイクルごとに1層ずつ積む」
ALD(Atomic Layer Deposition:原子層堆積)とは、1回のサイクルで原子レベルの極薄い膜(数Å=0.数nm)を1層だけ作り、それを必要な厚さになるまで何百〜何千回繰り返す成膜技術です。
最大の特徴は「自己制御(self-limiting)反応」。原料ガスを2種類交互に流すことで、表面が反応し終わるとそれ以上は積もらない、という仕組みを使います。だから、流す時間や量を多少間違えても、勝手に1層分でストップするのです。
ALDは「マグネット式の壁紙貼り」のイメージです。マグネットがついた台紙(ウェーハ表面)に、磁石入りの紙(原料A)を1枚貼ると、ピッタリ全面に1枚分だけ吸着して、それ以上は重ならない。次に、その上から別の紙(原料B)を貼ると、また1枚だけ反応してくっつく。これを繰り返せば、誰がやっても完璧に1層ずつ積み上がる──これがALDの「自己制御」の本質です。
化学反応が「表面が満たされたら自動的に止まる」性質。ALDの最大の特徴。原料ガスをどれだけ多く流しても、1層以上は付かない。これにより、装置のばらつきや時間管理が多少甘くても、原子レベルで均一な膜が作れる。
🔄 ALDの4ステップサイクル
ALDの1サイクルは、4つのステップを順番に繰り返します。これが原子1層分の膜を作る単位です。
原料ガスA(例:金属を含む前駆体)をウェーハ表面に送る。表面にぴったり1層だけ吸着。それ以上は付かない(自己制御)。
余分な原料Aを窒素ガスで吹き飛ばして除去。これをしないと次の反応が乱れる。
原料Bガス(例:水蒸気・酸素・オゾン等)を流す。表面の原料Aと反応して1層分の膜が完成。
余分な原料Bと副生成物を窒素で除去。これで1サイクル完了。STEP 1に戻り、必要な厚さになるまで繰り返す。
膜を作るための「原料化学物質」のこと。ALDでは特殊な金属化合物が使われる。例えばHfO₂(ハフニア)膜を作る場合は、TEMAH(テトラキスエチルメチルアミノハフニウム)といった有機ハフニウム化合物が前駆体として使われる。

ALD工程の役割と、作れる膜
🎨 ALDが必須の代表用途
ALDは「他の方法では作れない」場面で使われるのが特徴。コストが高くて遅いため、なくてはならない用途にだけピンポイントで投入されます。
最先端ロジックのGAAトランジスタでは、ナノシート構造の周囲をぐるりと膜で覆う必要があります。CVDでは凹凸の被覆性が足りず、PVDは方向性があってダメ。ALDだけが、3次元構造の隅々まで原子レベルで均一に膜を作れる──だから2nm世代以降ではALDが必須なのです。
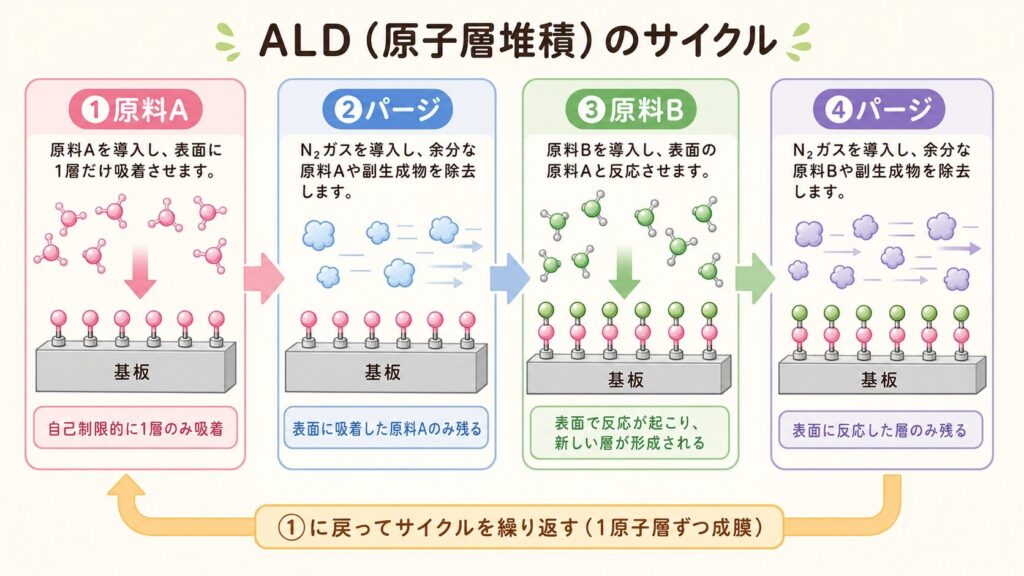
ALD vs CVD──「混ぜる」か「交互に流す」か
ALDとCVDはどちらも「ガスから膜を作る」という意味では似ていますが、反応の起こし方が決定的に違います。この違いがすべての特性差を生みます。
CVDは「鍋にすべての材料を一気に入れて煮込む」料理。早いけど、火加減や混ぜ方で味(膜質)がバラつきやすい。ALDは「材料を1つずつ順番に入れて、毎回お湯で鍋を洗いながら作る」超丁寧な料理。時間はかかるけど、誰が作っても完璧に同じ味になる──それがALDです。
| 比較項目 | 💨 CVD | 🧬 ALD |
|---|---|---|
| 原料の流し方 | 同時に混ぜて流す | 交互に流す(パージ付き) |
| 反応の場所 | 気相(空中)で反応 | 表面でのみ反応 |
| 膜厚制御 | 時間で制御(やや難) | サイクル数で完璧制御 |
| 凹凸への被覆性 | 良い | 完璧(究極) |
| 速度 | 速い | 遅い(数百サイクル) |
| 処理温度 | 200〜800℃ | 100〜400℃(低温) |
| 向く膜厚 | 中〜厚(〜数μm) | 超薄(〜数十nm) |
🎯 「凹凸への被覆性」がALDの真骨頂
ALDの最大の強みは「ステップカバレッジ(凹凸への被覆性)」。アスペクト比100:1(穴の深さが直径の100倍)のような極端な構造でも、底まで完璧に均一な膜を作れます。これはCVDでも難しく、PVDでは絶対不可能です。
・量産速度を重視
・凹凸が中程度
・極端な凹凸構造(GAA、3D)
・原子レベルの精度が必須
「ALDの方が高性能だから、すべてALDに置き換わる」と思いがちですが、ALDは速度が遅すぎてコストが高い。厚膜・低精度の用途では今もCVDが主役。「両者は補完関係」であり、どちらかが消えるという話ではありません。
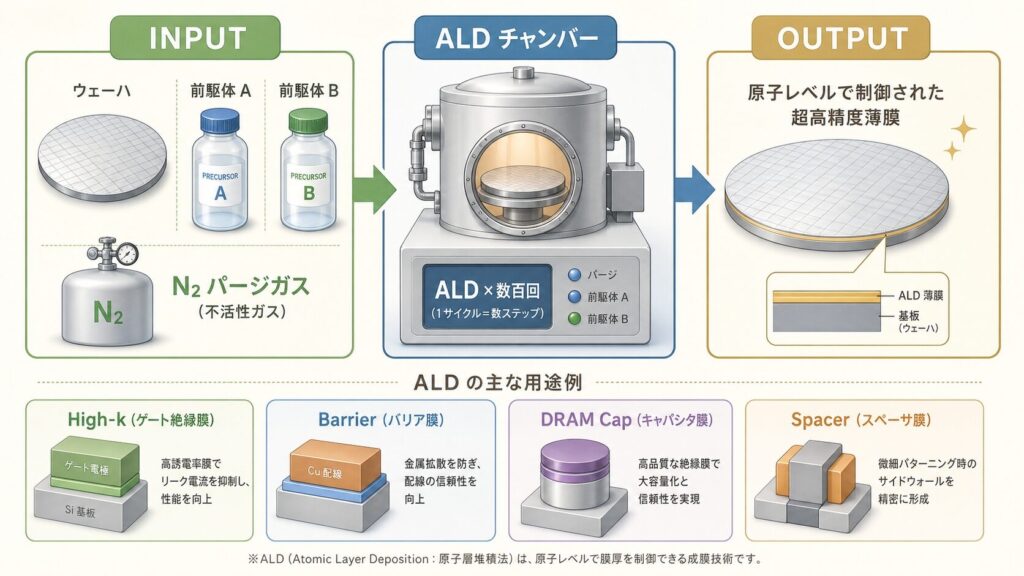
ALD装置の関連企業マップ──「ASM+日本3社」の住み分け
🏭 単一ウェーハ型はASM、バッチ型はKOKUSAI ELECTRIC
ALD装置は大きく「単一ウェーハ型(1枚ずつ)」と「バッチ型(数十〜100枚以上同時)」に分かれ、得意メーカーがはっきり分かれています。
装置メーカー
- ASM International(ASMI、オランダ)
単一ウェーハALDで世界シェア55%以上。GAA・High-kで圧倒的 - 東京エレクトロン(8035)
成膜全体トップ級。ALDも含むバッチ・枚葉両方 - Lam Research(LRCX)
誘電体ALD・先端ノードで強い - KOKUSAI ELECTRIC(6525)
バッチALDで世界シェア約7割(2023年第1位)
材料・前駆体メーカー
- ADEKA(4401)
High-k向け前駆体で高シェア - 三菱マテリアル電子化成
金属前駆体 - レゾナック(4004)
関連材料・特殊ガス - 大陽日酸(日本酸素HD)(4091)
パージ用窒素・反応ガス供給
使う側(ユーザー)
- TSMC(2330.TW)
GAA・3nm/2nmロジック - Samsung(005930.KS)
3D NAND・GAA・DRAM - SK Hynix(000660.KS)
HBM・DRAM - Intel(INTC)
RibbonFET(GAA) - Micron(MU)/キオクシア(285A)
📊 数字で見るALD市場
世界市場規模
(CAGR約11%)
世界シェア
バッチALD世界シェア
出典:Straits Research ALD市場レポート、ASMインターナショナル受注動向、東洋経済「KOKUSAI ELECTRICの魔法の成膜技術」を参照

AI半導体時代に「ALDが急成長する」3つの理由
ALDの成長は偶然ではなく、AI半導体時代の3つの構造変化に直接連動しています。
理由① GAAトランジスタ
2nm世代以降のGAA(Gate All Around)構造はナノシートの周囲を膜で完全に覆う必要があり、CVDでは被覆性が足りない。ALDが必須。
理由② 3D NAND高層化
3D NANDは200層・300層と縦方向に積層。深いトレンチの底まで均一に膜を作るのはALDだけ。HBM・DRAM高密度化でも同様。
理由③ High-k絶縁膜
ゲート絶縁膜が熱酸化のSiO₂からHfO₂などのHigh-k膜に置き換わる流れ。HfO₂はALDでしか高品質に作れない。
14nm世代では数十工程だったALDが、5nm世代で100工程以上、3nm/2nm世代では200工程超に達するとの業界推計があります。これがASM International・KOKUSAI ELECTRICの業績を構造的に押し上げる根本要因です。
📐 ALDが扱う精度
DNA二重らせんの直径(2nm)の20分の1。
これが現代の半導体技術の精度の最先端です。
📏 微細化世代マップ
先端ロジックでは7nm世代から主役、2nm GAA世代では不可欠。3D NAND・DRAM・HBMでも同様の重要性。
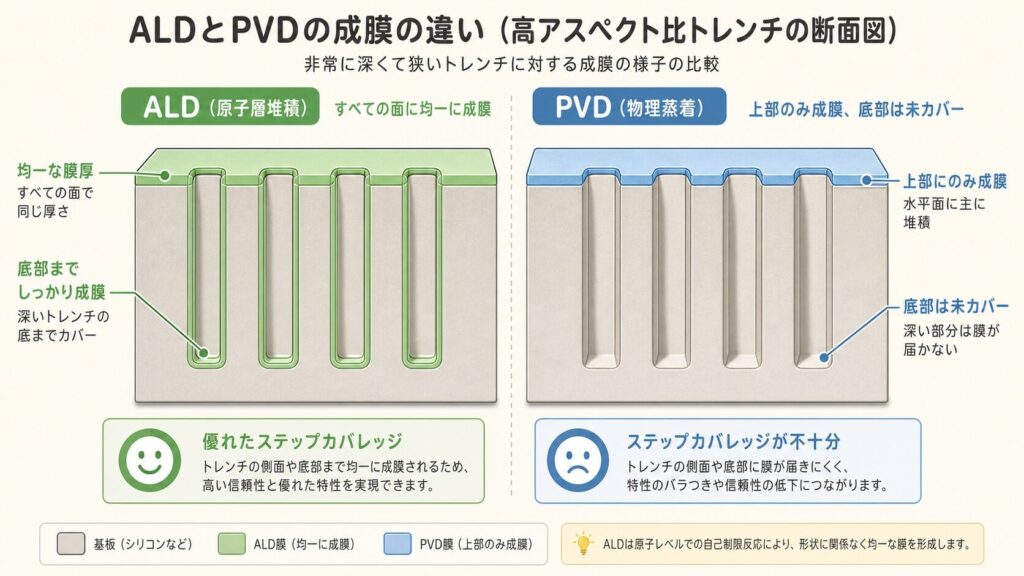
あなたにとっての意味──投資家・学生・技術者の視点

よくある誤解を整理する
| ❌ よくある誤解 | ✅ 実際はこう |
|---|---|
| 「ALDは究極だからすべての成膜に使えばいい」 | ALDは1サイクルで0.1nmしか積めないため非常に遅くてコストが高い。厚膜・量産用途では今もCVDが主役。用途で使い分けが鉄則。 |
| 「ALDはCVDの一種」 | 広い意味ではガスを使う点でCVDの仲間だが、「自己制御」「交互供給」「表面反応のみ」という点でCVDとは別物。原理がまったく違う。 |
| 「ASMインターナショナル=ASML(露光装置)」 | ASMインターナショナルとASMLは別会社。元は同じASM(Advanced Semiconductor Materials)が起源だが、1995年に別々に上場。ASMはALD等成膜、ASMLは露光装置。 |
| 「ALDは2nm時代だけの話」 | 2nm GAA以外にも、3D NAND・HBM・DRAMキャパシタ・MRAM・先端パッケージでALDが必須。AI半導体全体の構造変化を支える基盤技術。 |
| 「日本企業はALDで勝てない」 | バッチALDではKOKUSAI ELECTRICが世界シェア約7割。3D NAND・先端DRAMで圧倒的。前駆体材料ではADEKAも世界トップクラス。領域別で日本企業が世界をリード。 |
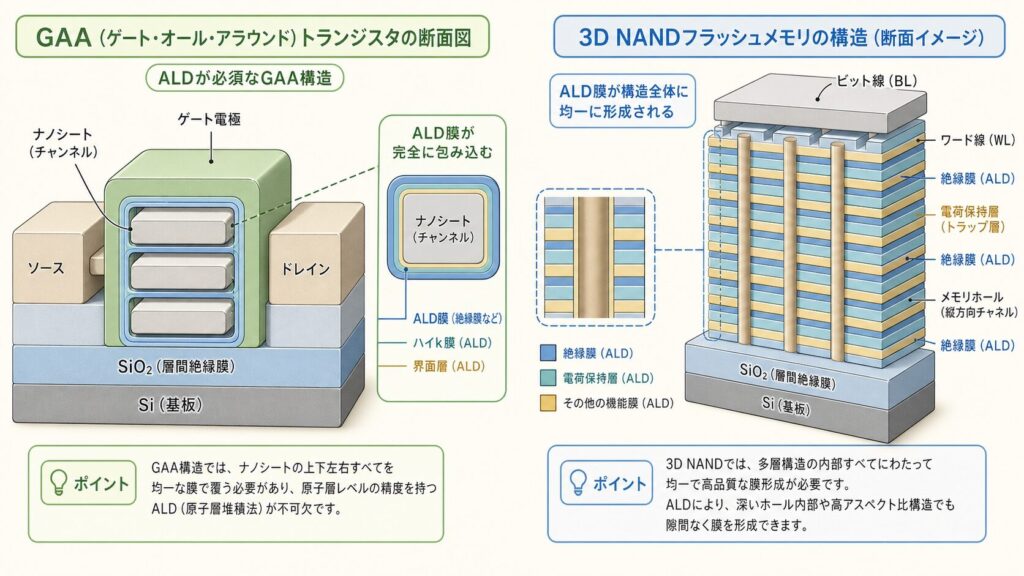
まとめ + FAQ
① ALDとは:原子1層ずつ膜を積む超精密成膜技術。1サイクルで約0.1nmずつ成長。
② 自己制御反応:原料Aと原料Bを交互に流して、表面反応で1層分だけ作る仕組み。装置のばらつきがあっても完璧な膜が作れる。
③ 4ステップサイクル:原料A供給→パージ→原料B供給→パージ。これを数百〜数千回繰り返す。
④ CVDとの違い:CVDは「混ぜて反応」、ALDは「交互に流して表面反応」。ALDは精度・被覆性で究極だが速度は遅い。
⑤ 用途:High-k絶縁膜(HfO₂)、バリアメタル、DRAMキャパシタ、スペーサー膜などAI半導体時代の中核領域。
⑥ 装置メーカー:ASM Internationalが単一ウェーハ型で世界シェア55%超、KOKUSAI ELECTRICがバッチ型で約7割。東京エレクトロン・Lam Researchも主要プレーヤー。
⑦ 市場規模:2024年62億ドル→2033年148億ドル(CAGR約11%)。GAA・3D NAND・HBM需要で急拡大中。
📚 次に読むべき記事
📖 ① 成膜とは?ウェーハに「膜」を積み重ねる工程 →
🎓 成膜シリーズ全6記事
📩 記事の更新情報を受け取りたい方へ
新しい記事が公開されたら、Xアカウント @shirasusolo でお知らせします。
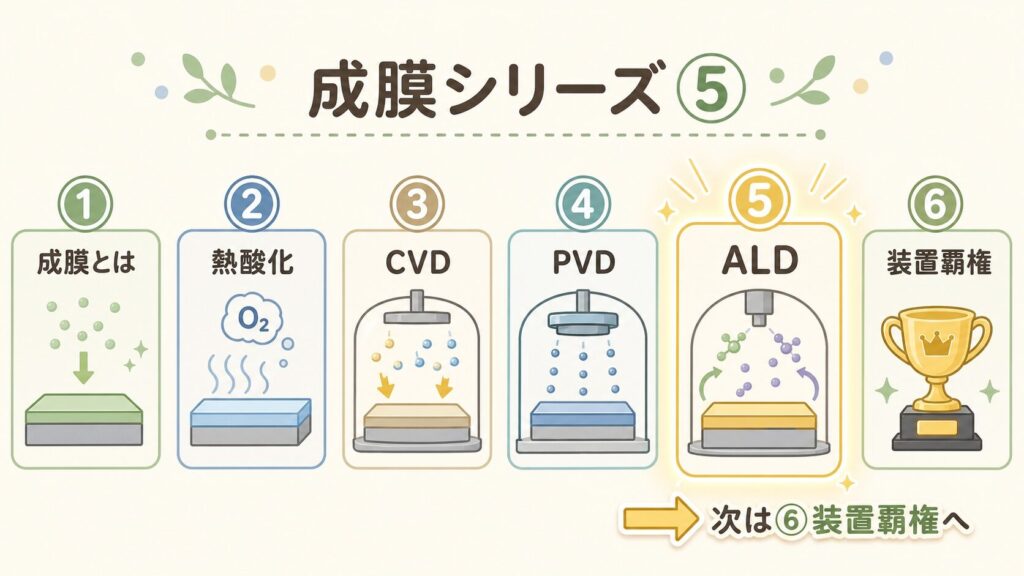
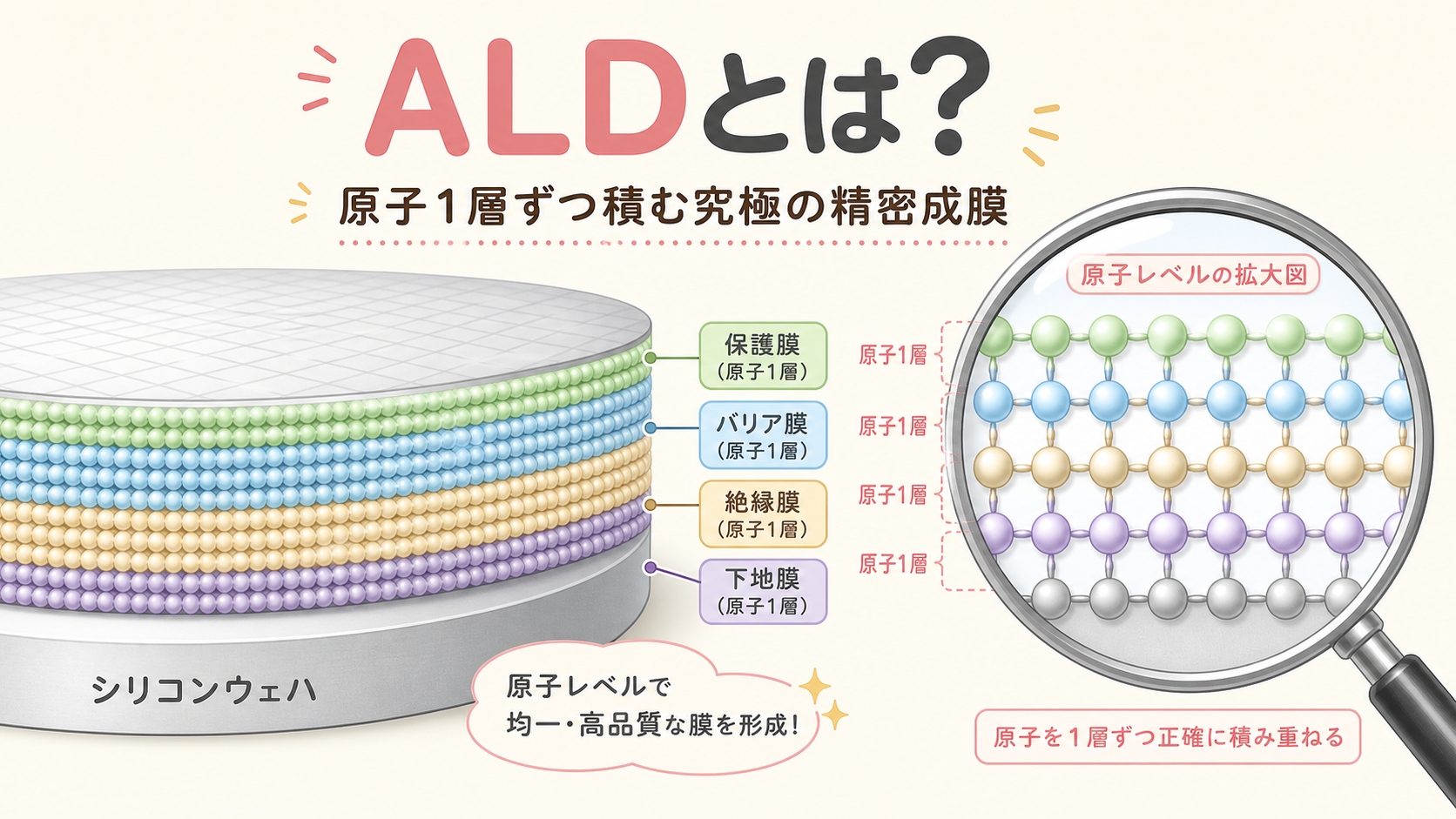


コメント