「EUV」──AI半導体の話題で必ず登場するこの言葉、こんなふうに感じていませんか?
- EUVは聞いたことあるけど、「13.5nm」が何を意味するか説明できない
- スズ・プラズマ・真空・ミラー…キーワードが飛び交うがつながりが見えない
- 「ASML 1社独占」「装置1台200億円超」と聞くけど、なぜそんなに高いのかわからない
- NVIDIA H100や2nmチップ製造との関係を構造で押さえたい
- 「13.5nm」を選んだ物理的な必然
- EUV装置の4つのキー技術(スズプラズマ・多層膜ミラー・真空・特殊レジスト)
- ArF液浸との決定的な違い(レンズが使えない理由)
- 1台200〜300億円の価格構造と、ASML独占の理由
- 2024年の出荷台数・主要ユーザーなど業界の今
シリーズ第3回(ArF液浸露光)で「業界が30年かけて行き着いた最後の関門がEUV」と紹介しました。今回はそのEUVの中身を、装置価格200億円超に納得がいくレベルまで深掘りします。
| 回 | タイトル | 区分 |
|---|---|---|
| 第1回 | リソグラフィとは?「設計図を焼き付ける」工程 | 入口 |
| 第2回 | リソグラフィ光源の歴史|i線→KrF→ArF→EUV | 時系列 |
| 第3回 | ArF液浸露光とは? | 技術 |
| 第4回 | 📍 EUVとは?13.5nmの極端紫外線(この記事) | 技術 |
| 第5回 | High-NA EUVとは?2nm世代の主役 | 次世代 |
| 第6回 | マルチパターニングとは? | 補完 |
| 第7回 | フォトマスク・レチクルとは? | 材料 |
| 第8回 | レジストとは?光で変質する薬品 | 材料 |
| 第9回 | ASMLが世界を握る理由|EUV独占の構造 | 業界 |

EUVとは?──30秒で全体像
EUV(Extreme Ultraviolet:極端紫外線)リソグラフィとは、波長13.5nmの光を使ってウェハに微細パターンを焼き付ける技術です。ArF液浸(実効134nm相当)の約10分の1の波長で、5nm・3nm・2nm世代の最先端ロジック半導体に必須となります。ただし13.5nmはあらゆる物質に吸収されるため、レンズが使えず、空気中も飛ばず、紙さえも通過できません。そのため装置は(1)スズ液滴にCO2レーザを当ててプラズマ化する特殊光源、(2)Mo/Si多層膜ミラーの反射光学系、(3)真空チャンバー、(4)EUV専用レジスト──というすべてが特殊技術の塊。1台200〜300億円、量産可能なメーカーはASML 1社のみです。日経クロステックによれば2023年の出荷台数は53台で、TSMC・Samsung・Intel・SK hynixが主要ユーザー。AI半導体時代の象徴的存在です。
📦 EUV露光の役割
ウイルス1個(約100nm)の7分の1。
DNA二重らせん直径(2nm)の約7倍のスケール。
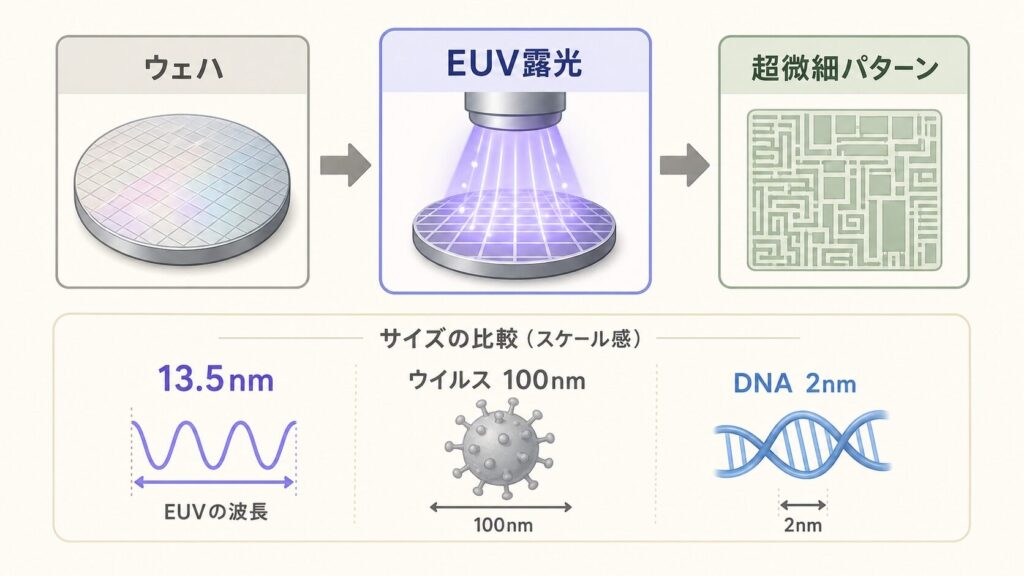
なぜ波長は「13.5nm」に決まっているのか
EUVの波長が13.5nmなのは、偶然ではなく物理的な必然です。理由は、後述するMo/Si多層膜ミラーが13.5nm付近で最も高い反射率(約70%)を示すから。「短波長を作る技術」と「短波長を反射する技術」の両方が成立する、わずかな『窓』がここでした。
「もっと短い波長(例:6nm)が使えればさらに細い線が引ける」のは事実ですが、その波長を反射できる材料が地球上にほぼ存在しないのです。「光源を作れる」「ミラーで反射できる」「材料が手に入る」の3条件が揃うピンポイントが13.5nmだった、という設計上の必然があります。
⚙️ EUV装置を支える4つのキー技術
EUV光は通常のレーザでは作れません。コマツ/ギガフォトン、ASML/Cymerが採用するのはLPP(Laser Produced Plasma)方式──応用物理学会誌・コマツ技報によれば、直径数十μmのスズ液滴に高出力CO2レーザを当てて瞬間的に数十万Kのプラズマ化し、そこから出るEUV光を取り出す方式。これを毎秒5万回繰り返します。
EUVはレンズを透過できません。代わりにモリブデンとシリコンを交互に40層以上積み重ねた多層膜ミラーで光を反射しながら導きます。1枚の反射率は約70%しかなく、装置内で6〜10枚反射すると光は2割以下に減衰。これが「光源出力を上げ続ける必要がある」最大の理由です。
13.5nm光は空気中の窒素・酸素にも吸収されてしまい、数cmで消えます。装置内部は徹底的に真空に保たれ、ウェハやマスクの搬入もすべて真空ロードロック経由。装置全体が宇宙空間並みの環境で動作します。
ArF用のレジストはEUVには使えません。EUVは光子1個のエネルギーが大きく感度設計が根本的に異なるため、金属酸化物レジストや化学増幅型の専用樹脂が必要。JSR・東京応化・信越化学などが世界供給の中心です。詳しくはシリーズ第8回で解説します。

ArF液浸との決定的な違い──「レンズが使えない」が起点
EUVがArF液浸の「強化版」ではなくまったく別物であることを理解するには、両者の構造を並べて比較するのが一番早道です。
| 比較項目 | ArF液浸 | EUV |
|---|---|---|
| 波長 | 193nm(実効134nm) | 13.5nm |
| 光学系 | 屈折レンズ(ガラス) | 多層膜ミラー(反射のみ) |
| 光源 | ArFエキシマレーザ | スズプラズマ+CO2レーザ |
| 環境 | 大気+水(液浸) | 真空 |
| マスク | 透過型(ガラス基板) | 反射型(多層膜マスク) |
| 単層解像度 | 約38nm | 約13nm以下 |
| 装置価格 | 数十億円 | 200〜300億円 |
| 主な対応世代 | 45〜7nm | 7nm以降 |
出典:日経クロステック、TEL museum、ASML公開資料等を基に作成。
🌌 EUV光の旅(光源→ウェハまで)
ArF液浸では「光源→透過レンズ→水→ウェハ」とシンプル。一方EUVは光源→ミラー集光→さらに6〜10枚のミラーを反射しながら導く。各ミラーの位置は0.1nm精度で合わせる必要があり、これがASML以外には作れない理由の一つです。
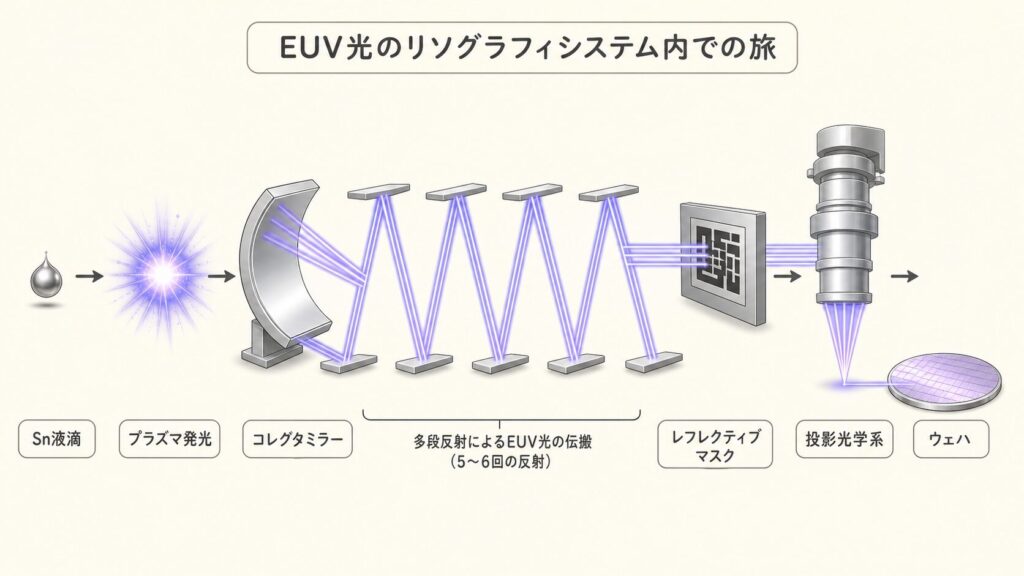
2024年の現実──出荷台数・主要ユーザー・1台あたりコスト
EUVは「夢の技術」ではなく、すでに量産現場で当たり前のように稼働している段階です。具体的な数字で押さえましょう。
(日経クロステック)
(業界推定・モデルにより異なる)
(ASML独占・TEL museum)
主要ユーザーと採用ノード
| ユーザー | EUV採用開始 | 主な用途 |
|---|---|---|
| TSMC(2330.TW) | 2019年 N7+から | A17 Pro / NVIDIA H100 / B200 |
| Samsung Foundry | 2019年 7nmから | Exynos / DRAM(先端メモリ) |
| SK hynix | 2021年 1αnm DRAMから | DDR5 / HBM |
| Intel(INTC) | Intel 4から本格採用 | Meteor Lake / Foundry事業 |
| Micron(MU) | 1γnm DRAM以降 | DRAM / HBM3E |
| Rapidus(非上場) | 2025年〜(予定) | 2nm世代 |
2025年7月、応用物理学会誌の記事によれば、日本のRapidusに複数台のEUV装置が納入されたとされ、これが日本で初の量産用EUVとなる見通し。AI半導体の地政学的な再編が、EUV装置の納入先の変化に直結しています。

関連企業マップ──EUVを支えるエコシステム
露光装置メーカー
- ASML(ASML.AS)
世界唯一のEUV量産メーカー
※ニコン・キヤノンはEUVから事実上撤退
光源・光学・材料
- Cymer(ASML子会社・米)
EUV光源の主役 - TRUMPF(独・非上場)
高出力CO2レーザを供給 - Zeiss(独・非上場)
Mo/Si多層膜ミラー光学系 - JSR(4185 ※非上場化進行中)/東京応化(4186)/信越化学(4063)
EUVレジスト - HOYA(7741)
EUVマスクブランクス
使う側(ユーザー)
- TSMC(2330.TW)
EUV最大ユーザー - Samsung/SK hynix
DRAM・HBM・ロジック - Intel(INTC)/Micron(MU)
先端ロジック・DRAM - Rapidus(非上場)
2nm量産で2025年〜採用
どの世代でEUVが必須か
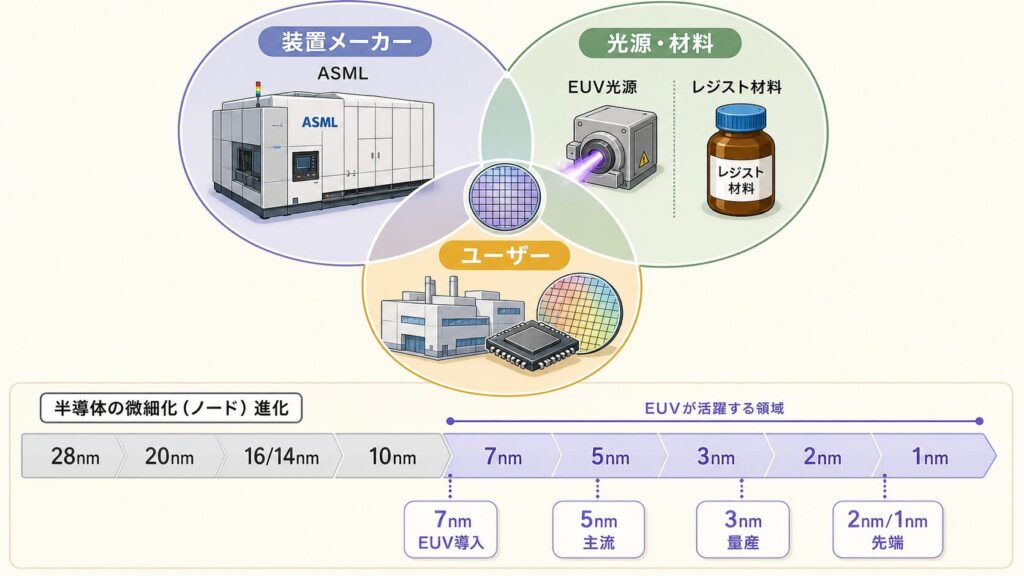
あなたにとっての意味──投資家・学生・技術者
EUV関連の投資テーマは「ASML 1社」だけではありません。光源(コマツ 6301 子会社のギガフォトン、独TRUMPF)、光学(Zeiss)、レジスト(JSR・東京応化・信越化学・富士フイルム)、マスクブランクス(HOYA 7741)など、日本企業も多くがエコシステムの中核を占めています。「EUV = ASML」だけでなく、サプライチェーン全体を地図化する視点が重要です。
EUV装置はプラズマ物理・X線光学・真空工学・精密制御・レジスト化学のすべてが交差する分野。物理学・応用物理・材料科学の研究テーマと地続きです。日本では大阪大学レーザー科学研究所、東京大学、産総研などがEUV関連研究で世界トップレベルにあり、博士課程の進路としても豊富な機会があります。
EUVは「光源出力」がスループット(生産性)に直結する世界。ミラー反射率70%×6〜10枚で光が大幅減衰するため、光源は数百W級の出力が必要。担当工程外でも、EUVニュースを読むときは「光源出力(W)と1時間あたりウェハ枚数」を見ると、世代の優劣を直感的に判断できます。
よくある誤解の整理
EUV光はレーザではなくプラズマ光(インコヒーレント光)です。CO2レーザはあくまで「スズをプラズマ化するためのドライバ」。光源の正体はスズプラズマからの自然放射。レーザのようにコヒーレントではありません。
EUVマスクは透過型ではなく反射型。ガラスではなく多層膜の上にパターンを形成し、ペリクル(保護膜)すらEUVを通せる素材を新たに開発する必要がありました。価格はArFマスクの5〜10倍ともいわれます。詳しくはシリーズ第7回で解説。
EUVでも2nm以下では再びマルチパターニング併用が必要になります。「EUV → 単層で全部できる」は3〜5nm世代までの話。これ以上の微細化にはHigh-NA EUVや新たなマルチパターニング併用が必要です。

まとめ:EUVの全体像
① 定義:波長13.5nm(極端紫外線)でウェハに焼き付けるリソグラフィ技術。ArF液浸の約10分の1の波長。
② なぜ13.5nmか:「光源が作れる」「ミラーで反射できる」「レジストが反応する」3条件が揃うピンポイントが13.5nm。
③ 4つのキー技術:(1) スズプラズマ光源(LPP方式)、(2) Mo/Si多層膜ミラー、(3) 真空チャンバー、(4) EUV専用レジスト。
④ ArF液浸との違い:レンズが使えない/真空が必要/反射型マスク/装置価格10倍以上──ほぼ別物の技術。
⑤ 業界構造:装置はASML独占(量産可能メーカー1社のみ)/2023年出荷53台/1台200〜300億円/TSMC・Samsung・Intel・SK hynix・Micron・Rapidusが採用。
❓ よくある質問(FAQ)

次に読むべき記事
| 回 | タイトル | 区分 |
|---|---|---|
| 第1回 | リソグラフィとは?「設計図を焼き付ける」工程 | 入口 |
| 第2回 | リソグラフィ光源の歴史|i線→KrF→ArF→EUV | 時系列 |
| 第3回 | ArF液浸露光とは? | 技術 |
| 第4回 | 📍 EUVとは?13.5nmの極端紫外線(この記事) | 技術 |
| 第5回 | High-NA EUVとは?2nm世代の主役 | 次世代 |
| 第6回 | マルチパターニングとは? | 補完 |
| 第7回 | フォトマスク・レチクルとは? | 材料 |
| 第8回 | レジストとは?光で変質する薬品 | 材料 |
| 第9回 | ASMLが世界を握る理由|EUV独占の構造 | 業界 |
- HBMとは?GPUの隣にある「AI最重要メモリ」 ── EUVで作られたDRAMダイを積層する技術
- 先端パッケージとは?AIチップの「組み立て方」が変わった理由
- AIデータセンターとは?従来型との違いと構造を解説
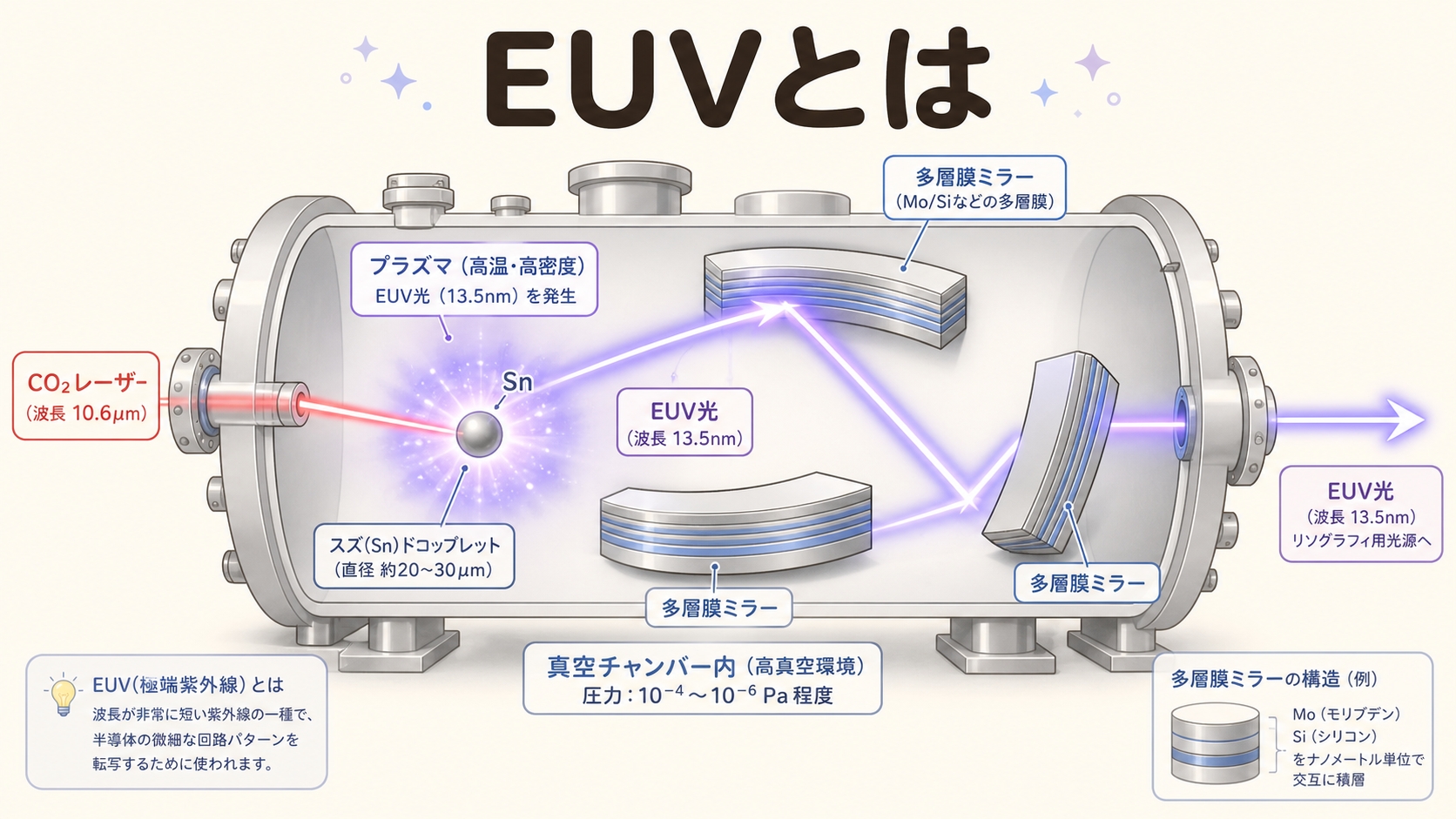


コメント